สถานการณ์นี้เป็นเรื่องที่น่าหงุดหงิดเป็นอย่างยิ่ง. บอร์ดซับซ้อนที่เต็มไปด้วยแผนกันทองแดงหนาแน่น โผล่ขึ้นมาจากเตา reflow การตรวจสอบพบกลุ่มความผิดปกติหัวในหมอน (HiP) ใต้ BGA ขนาดใหญ่ - วงจรเปิดที่ร้ายกาจซึ่งสนิมบัดกรีและแผ่นบัดกรีไม่สามารถรวมกันได้. สัญชาตญาณแรกคือการเพิ่มปริมาณบัดกรีแต่ถังดูเหมือนสมเหตุสมผล: หากการเชื่อมต่อไม่เกิดขึ้น ก็แค่เพิ่มวัสดุ!

สัญชาตญาณนี้ผิด. ใน PCBA Bester เราเคยเห็นวิธีนี้ล้มเหลวซ้ำแล้วซ้ำเล่า สำหรับการประกอบที่มีมวลความร้อนสูง การเติม paste ให้เต็ม pad เป็นการไม่สนใจตัวการของปัญหา ความผิดปกติไม่ใช่การขาดบัดกรี แต่เป็นการสูญเสีย coplanarity ชั่วคราวและรุนแรงที่เกิดจากฟิสิกส์ของการโอนความร้อน โซลูชันไม่ได้อยู่ที่การใช้ stencil เปิดที่ใหญ่ขึ้น แต่ใน การควบคุมแบบมีวินัยของกระบวนการประกอบทั้งหมดของคุณ
โครงสร้างของความผิดปกติที่ดื้อรั้น: การบิดงอ, การล่าช้าของความร้อน, และความไม่รู้เท่าทันที่ล้มเหลว
แผ่นวงจรพิมพ์ไม่ใช่แผ่นกลาสออร์โต้แบบไม่ปฏิกิริยา มันเป็นคอมโพสิทของวัสดุที่มีคุณสมบัติความร้อนแตกต่างกันอย่างมาก เมื่อแผ่นที่มีมวลความร้อนสูงจากพื้นผิวทองแดงหนาหรือรูปแบบที่หนาเข้าสู่เตา reflow มันต่อต้านการเปลี่ยนแปลงอุณหภูมิ ซึ่งสร้างเงื่อนไขที่สมบูรณ์แบบสำหรับความผิดปกติ HiP
ความท้าทายหลักของมวลความร้อนสูง
มวลความร้อนสูงทำหน้าที่เป็น sink ความร้อน ทำให้เกิดการล่าช้าของความร้อนอย่างรุนแรง ขอบนอกและอุปกรณ์บนผิวของบอร์ดร้อนขึ้นอย่างรวดเร็ว แต่ชั้นในและ ground plane ด้านล่างของอุปกรณ์ดูดซับพลังงานความร้อนช้ากว่ามาก การให้ความร้อนแบบต่างๆนี้เป็นเครื่องยนต์ที่ผลักดันการบิดงอที่เปลี่ยนแปลงได้ในระหว่าง reflow บอร์ดบิดเบี้ยวทางกายภาพในเตา และความบิดเบือนนี้ไม่ได้เป็นแบบสม่ำเสมอหรือคงที่
การโต้แย้งเรื่อง “เพิ่มเติม Paste”: ปัญหาเกี่ยวกับเวลา มากกว่าปริมาณ
การเพิ่ม paste มากขึ้นล้มเหลวเพราะมองว่า HiP เป็นเพียงปัญหาในการเติมช่องว่าง อย่างไรก็ตาม ช่องว่างเป็นสิ่งไดนามิก การเติม paste ที่ใหญ่ขึ้นอาจทำให้ตกลง ริษีการเชื่อมต่อ และยังล้มเหลวในการสัมผัสกับลูกบัดกรี BGA ซึ่งชิ้นส่วนได้ยกตัวขึ้นชั่วคราวเนื่องจากการบิดงอ ความล้มเหลวหลักคือความผิดพลาดในการจัดเวลา: บัดกรีหลอมและกิจกรรมของ flux ถูกใช้หมดในขณะที่ BGA ยังอยู่ในจุดที่เคลื่อนที่ไกลที่สุด เมื่อบอร์ดเรียบในภายหลังในโปรไฟล์ paste จะกลายเป็นมวลดินที่ออกซิไดซ์และไม่สามารถเปียกได้ การเชื่อมต่อพังเพราะไม่ได้สัมผัสกันในช่วงเวลาที่ Liquidus — ปัญหาซึ่ง volume เพียงอย่างเดียวไม่สามารถแก้ไขได้
หลักการเบื้องต้น: ฟิสิกส์ของการเคลื่อนที่ของการแปรผันของ coplanarity
ในการแก้ไขความผิดปกตินี้ คุณต้องเข้าใจแรงที่มีผลอยู่ ความผิดปกติ HiP บนบอร์ดมวลความร้อนสูงเป็นเรื่องของการต่อสู้ทางกายภาพระหว่างส่วนประกอบและ PCB ซึ่งต่อสู้ด้วยอาวุธของอุณหภูมิ
การต่อสู้ของอุณหภูมิ: วิธีที่แนวโน้มความร้อนทำให้เกิดการบิดงอ

เมื่อการประกอบเคลื่อนไปผ่านเตา reflow ส่วนต่างอุณหภูมิที่สำคัญ หรือ delta-T เกิดขึ้นระหว่างบริเวณที่เบาและหนัก BGA ซึ่งมีมวลความร้อนต่ำจะร้อนขึ้นอย่างรวดเร็ว พื้นที่ของ PCB ที่อยู่ด้านล่างตรงนั้น ซึ่งมักจะเชื่อมต่อกับพื้นผิวกราวด์ขนาดใหญ่ จะร้อนขึ้นช้ากว่ามาก delta-T นี้ทำให้เกิดการขยายตัวต่างกัน BGA ขยายตัวเร็วกว่าบอร์ดด้านล่าง ซึ่งนำไปสู่การบิดงอเป็นรอยยิ้ม ที่ตรงกลางของคอมโพเนนต์ลอยตัวจาก PCB ซึ่งสร้างช่องว่างที่เป็นลักษณะของสภาพหัวอยู่ในหมอน
BGA กับบอร์ด: การแข่งเพื่อเข้าสู่สถานะ Liquidus
การบิดงอนี้รุนแรงที่สุดในช่วง ramp-to-peak ของโปรไฟล์ reflow—ซึ่งสำคัญคือ เมื่ออัลลอยย์ของบัดกรีเข้าสู่จุดหลอมเหลว Ball ของ BGA ซึ่งร้อนขึ้นอย่างรวดเร็วจะเป็นของเหลวและเตรียมสร้างข้อต่อ ส่วน paste ของบัดกรีบนแผ่น PCB ยังคงพยายามเข้าสู่จุดอุณหภูมิ เนื่องจากดีเลย์ทางความร้อนของบอร์ด ผลลัพธ์คือความผิดพลาดอย่างรุนแรง ลูกบอล BGA เป็นของเหลว แต่ paste ยังคงไม่ละลายเต็มที่หรือช่องว่างที่เกิดจากการบิดงอใหญ่เกินกว่าจะเชื่อมต่อก่อนที่ flux จะหมด สิ้น ข้อต่อจึงล้มเหลว
หนังสือกลยุทธ์ความร้อน: เชี่ยวชาญด้านโปรไฟล์ reflow
เนื่องจากสาเหตุหลักคือทางความร้อน วิธีแก้ไขต้องเป็นทางความร้อน โปรไฟล์ reflow ของคุณเป็นเครื่องมือที่ทรงพลังที่สุดในการลดการบิดงอแบบไดนามิก เป้าหมายไม่ใช่แค่ละลายบัดกรี แต่เพื่อจัดการ delta-T ทั่วทั้งการประกอบ เพื่อให้ทุกอย่างเข้าสู่สถานะหลอมเหลวพร้อมกันในระดับเดียวกัน
การขยายนาทีเพื่อสมดุลทางความร้อน
สำหรับบอร์ดที่มีมวลความร้อนสูง โซน soak ที่ยาวขึ้นและควบคุมอย่างระมัดระวังเป็นสิ่งที่ไม่สามารถเจรจาได้ โปรไฟล์ soak สั้นๆ ที่ใช้ได้กับบอร์ดง่ายจะล้มเหลวที่นี่ ช่วงเวลา soak ที่ต่อเนื่องใกล้จุดละลายของบัดกรีช่วยให้บริเวณที่แข็งแรงทางความร้อนของบอร์ด “ตามให้ทัน” กับบริเวณที่เบากว่า โดยการลด delta-T ทั่วทั้งการประกอบ ก่อนหน้านี้ ในช่วงสุดท้ายของ ramp to peak คุณจะลดแรงขับเคลื่อนของการบิดงออย่างมาก การประกอบเข้าสู่โซนพีคที่สำคัญในสภาวะสมดุลทางความร้อน
เวลาเหนือ Liquidus ที่มีวินัย: การสร้างข้อต่อแบบแบนราบ
เมื่อเข้าสู่สมดุล เวลาที่เกิน Liquidus (TAL) เป็นพารามิเตอร์ถัดไปที่สำคัญ ความผิดพลาดที่พบได้บ่อยคือ TAL สั้นเกินไป ซึ่งไม่เพียงพอสำหรับการวอทติ้งเต็มที่ หรือยาวเกินไป ซึ่งทำให้ส่วนประกอบเสียหายและหมด flux สำหรับ HiP เป้าหมายคือ TAL ที่ใช้เวลาเพียงพอสำหรับให้เกิดสองสิ่ง: ให้บัดกรีที่หลอมละลายรวมตัวกันเต็มที่ และให้บอร์ดและคอมโพเนนต์ “ผ่อนคลาย” เข้าสู่สภาพแบนราบมากขึ้นเมื่ออุณหภูมิเหมือนกันที่จุดพีค การมีวินัยนี้สร้างข้อต่อที่แบนราบและแข็งแรง สำหรับผู้ที่ใช้เตาที่มีโซนให้ความร้อนน้อย การบรรลุ TAL ที่ยาวและเสถียรอาจเป็นเรื่องท้าทาย ในกรณีเหล่านี้ การปรับความเร็ว ramp โดยรวมให้ช้าลงสามารถจำลองการ soak ที่ยาวขึ้น ให้บอร์ดมีเวลามากขึ้นในการสมดุล แม้จะทำให้โปรไฟล์โดยรวมยาวนานขึ้นก็ตาม
น beyond the profile: การแทรกแซงเชิงกลและเชิงวัสดุ
ในขณะที่โปรไฟล์ความร้อนเป็นดารานำ สองแนวทางอื่น ๆ ให้ทางออกที่สมบูรณ์และแข็งแรงโดยการแก้ไขด้านกายภาพและเคมีของปัญหา
การควบคุมบอร์ดด้วยการสนับสนุนที่เหมาะสม
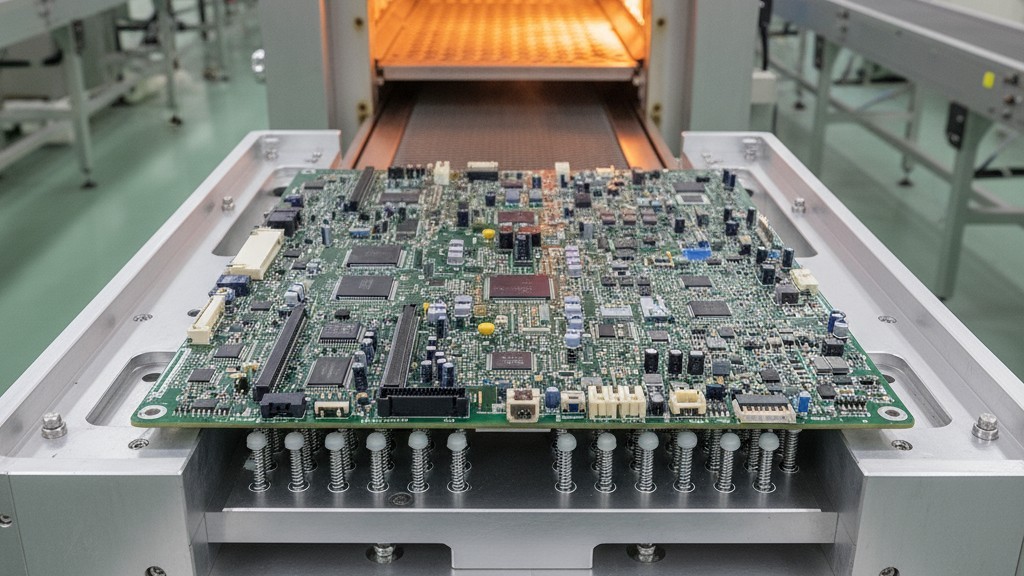
ถ้าแนวโน้มความร้อนเป็นเครื่องยนต์ของการบิดงอ การไม่มีการสนับสนุนทางกายภาพเป็นสิ่งที่ปล่อยให้มันวิ่งอย่างอิสระ กระดานที่มีมวลความร้อนสูง โดยเฉพาะใหญ่หรือบาง ต้องได้รับการสนับสนุนอย่างเหมาะสมในเตา การพึ่งพาเพียงสายพานขอบธรรมดาไม่เพียงพอ เราแนะนำอย่างยิ่งให้ใช้การสนับสนุนเฉพาะทางที่มีพินสัมผัสกับขอบและตรงกลางของแผง PCB โดยเฉพาะบริเวณรอบ BGA การสนับสนุนกลไกลนี้ช่วยขัดขวางการบิดงอของแผงอย่างมีประสิทธิภาพและปรับปรุงความขนานของแผงอย่างมาก
การเลือกอาวุธของคุณ: ตะกั่วบัดกรี High-Tack, Low-Slump
เทปบัดกรีเองก็เป็นผู้มีส่วนร่วมในกระบวนการนี้ เมื่อเผชิญกับ HiP บนบอร์ดเหล่านี้ เคมีของเทปเป็นสิ่งสำคัญ คุณต้องการเทปที่มีความติดแน่นเป็นพิเศษและแพ็คเกจฟลักซ์ที่แข็งแรง เทปที่ติดแน่นสูงทำให้แน่ใจได้ ถึงแม้จะมีการแยกเล็กน้อยเกิดขึ้น ก็ยังคงติดต่อกันทางกายภาพกับลูกบอล BGA ฟลักซ์ต้องถูกออกแบบให้สามารถทนต่อโปรไฟล์การแช่ที่ยาวนานโดยไม่สูญเสียกิจกรรม พร้อมที่จะทำความสะอาดออกไซด์ในทันทีที่บรรลุ liquidus เทปที่มีประสิทธิภาพต่ำหรือฟลักซ์อ่อนจะทำให้ทุกอย่างแย่ลง
การตรวจสอบการแก้ไข: จากการควบคุมกระบวนการไปยังเอ็กซ์เรย์

การดำเนินการเปลี่ยนแปลงเหล่านี้เป็นครึ่งหนึ่งของการต่อสู้ การตรวจสอบความถูกต้องของความสำเร็จเป็นอีกครึ่งหนึ่ง การทำโปรไฟล์ความร้อนอย่างสม่ำเสมอเป็นสิ่งสำคัญเพื่อให้แน่ใจว่ากระบวนการของคุณยังคงควบคุมได้ โปรไฟล์ที่สำเร็จและบันทึกไว้ซึ่งกำจัด HiP ควรได้รับการตรวจสอบเป็นประจำ
ในที่สุด หลักฐานที่แน่นอนมาจากการตรวจสอบ ในขณะที่การตรวจสอบด้วยสายตาสามารถให้เบาะแสได้ วิธีเดียวที่จะมั่นใจได้ว่า HiP ได้ถูกกำจัดออกไปคือผ่านการตรวจสอบด้วยรังสีเอ็กซ์อัตโนมัติ (AXI) มุมมองตัดขวางจากรังสีเอ็กซ์จะแสดงให้เห็นอย่างชัดเจนว่าการเชื่อมต่อด้วยเทปที่สมบูรณ์และเป็นเนื้อเดียวกัน ซึ่งยืนยันว่าวิธีการที่วางแผนและดำเนินการตามขั้นตอนของคุณประสบความสำเร็จในสิ่งที่การเพิ่มเทปธรรมดาเท่านั้นล้มเหลว
