صمت نموذج تجريبي ميت ثقيل. ليس فقط عدم وجود ضوضاء مروحة أو أضواء LED الداكنة على واجهة التصحيح. إنه الحساب الفوري والغارق للتكلفة. عندما يفشل لوحة النموذج الأولي في التهيئة — ربما لم يجلس BGA بشكل صحيح أثناء التجميع، أو يطلب عيب تصميم استبداله — يتضيق التركيز فورًا إلى المربع الأسود الكبير في مركز لوحة الدائرة المطبوعة.

في قطاعات الاعتمادية العالية، غالبًا ما يكون ذلك المربع هو FPGA فائق المستوى، مثل Xilinx Kintex UltraScale أو Intel Stratix 10. هذه ليست مكونات سلعية؛ فهي أصول. في أوقات ضيق سلسلة التوريد، قد يتطلب استبدال ذلك الرقاقة الواحدة وقت تسليم يصل إلى 52 أسبوعًا أو زيادة سعر السوق من قبل الوسيط الذي يكسر ميزانية المشروع. قد تمثل تكلفة تصنيع وتجمع اللوحة ذاتها، المصنوعة من تكوين من 12 طبقة مع فتحات عمياء ومكبوتة، $5,000. إعادة العمل ليست إصلاحًا قياسيًا. إنها عملية إنقاذ حيث يكون جدول التطوير بأكمله على المحك.
الفيزياء لا تفاوض
لا تزال هناك misconception خطيرة وهي أن إزالة Ball Grid Array (BGA) هي مسألة تطبيق حرارة حتى يذوب اللحام. هذا الموقف يدمر النماذج الأولية. مسدسات الحرارة المحمولة، على الرغم من أنها ممتازة لتصغير الأنابيب، فهي أدوات تدمير للربط عالي الكثافة.
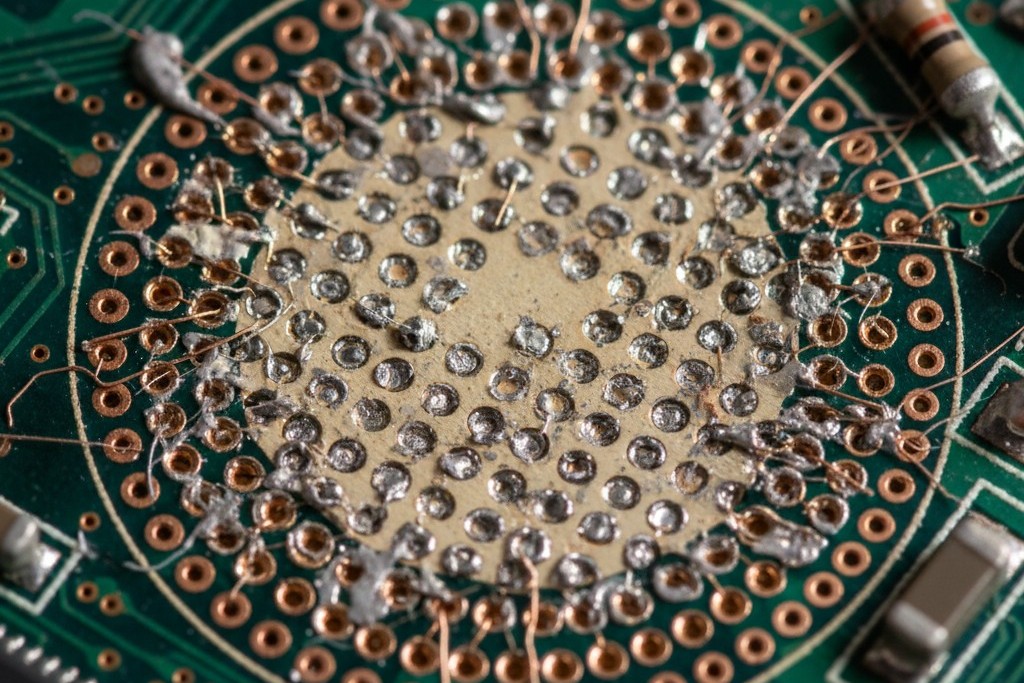
الفيزياء تعتمد على الكتلة الحرارية ومعامل التمدد الحراري (CTE). يوجد جهاز FPGA حديث على لوحة مملوءة بأرضيات نحاسية مصممة خصيصًا لتبديد الحرارة. إذا قمت بضخ الهواء الساخن على رأس الشريحة بدون تدفئة كافية لأسفل اللوحة، ستنشئ تدرج حراري رأسي. يتوسع الجزء العلوي بينما يظل الأسفل باردًا وصلبًا. النتيجة هي التشوه. مع انحناء اللوحة، يسحب ضد وصلات اللحام. إذا كانت مصدر الحرارة غير مضبوط، فإنك تخاطر بـ
لهذا السبب يجب على المهندسين اعتماد طريقة التصنيع المحلية. الهدف هو تكرار ملف تعريف إعادة التدفق الأصلي — المنحنى المحدد لدرجة الحرارة على مدى الزمن — الذي شهدته اللوحة في فرن التصنيع. يجب أن يتم رفع التجميع بأكمله إلى درجة حرارة نقع (عادةً حوالي 150°C إلى 170°C) لتنشيط التدفق وتساوي درجة الحرارة عبر لوحة الدائرة المطبوعة. بعد ذلك فقط يجب عليك تطبيق طاقة مركزة على المكون نفسه لدفعه فوق نقطة السائل عند 217°C. الفيزياء تتجاهل المواعيد النهائية؛ إذا كان التصعيد الحراري حادًا جدًا، فإن الرطوبة المحتجزة داخل عبوة الشريحة سوف تتوسع إلى بخار، مما يتسبب في تقشر العبوة أو
العملية: تدخل مراقب
إنقاذ مكون بقيمة $2,000 يتطلب دقة. يبدأ العملية قبل أيام من إعادة العمل الفعلي بمعالجة الرطوبة. ما لم يتم تخزين اللوحة في صندوق جاف مع مؤشرات رطوبة تقرأ مستويات آمنة، يجب أن تتعرض للخبز. تفرض بروتوكولات IPC-1601 خبز الرطوبة من لوح الدائرة المطبوعة والمكون لمنع التفاعل الناتج عن ضغط البخار الناتج عن التفاعل. تخطي هذه الخطوة هو السبب الأكثر شيوعًا لظهور عيوب غير مرئية تظهر بعد أسابيع.
بمجرد أن يجف اللوح، ينتقل إلى نظام إعادة عمل مخصص — عادةً آلة مزودة بتركيب بصري مجزأ، ومحمص بالأشعة تحت الحمراء من الأسفل، وأنبوب من الهواء الساخن يتحكم به الكمبيوتر من الأعلى. يأتي الأتمتة بقيادة هذه العملية، وليس اللمس اليدوي. يتم تثبيت مجس حرارة غالبًا على لوح تضحية لرسم الملف التعريفي الحراري بدقة. نحتاج إلى معرفة أنه عندما يقول الجهاز 230°C، فإن كرات اللحام الموجودة تحت مركز تلك الشبكة 35x35 مم تصل فعليًا لعملية إعادة التدفق، وليس تبقى باردة بسبب مبرد حرارة قريب.
إزالة الرقاقة نفسه غير مثيرة إذا كان الملف التعريفي صحيحًا. ينخفض فوهة الفراغ، يذوب اللحام، وترتفع المكون عموديًا بدون قوة. ي peaks القلق مباشرة بعدها: تجهيز الموقع. يتضمن ذلك إزالة اللحام القديم يدويًا من وسادات لوحة الدائرة المطبوعة باستخدام مسمار لحام وشريط الخيط. هنا أهمية يدي الفنانيْن أكثر. يجب أن يطفو الحديد فوق الوسادات؛ أي ضغط أسفل يهدد برفع وسادة، وهو عادة مميت للوحة. على الرغم من وجود طرق لإصلاح الوسادات المرفوعة باستخدام الإبوكسي، فإن فرض تباين المعاوقة الناتج عن الإصلاح غالبًا ما يكون غير مقبول لخطوط FPGA عالية التردد. يجب أن تكون الوسادات نظيفة ومسطحة ولامعة نحاسيًا قبل وضع رقاقة جديدة أو معاد تذويبها.
معادلة إعادة التبليل

أحيانًا لا يكون الهدف رقاقة جديدة، بل إنقاذ القديمة من لوحة ميتة للاستخدام في مكان آخر، أو إعادة تثبيت رقاقة كانت تعاني من فشل في الاتصال. يُدخل هذا الفرع الفرعي من إعادة التبليل. تحتوي رقاقة BGA التي تم إزالتها على نبضات لحام فوضوية وغير منتظمة على الجزء السفلي منها. يجب تنظيفها بإزالة واستبدال كرات اللحام الجديدة.
إنها حساب عائد استثمار نقي. إعادة تعبئة مِيكروكونترولر للسلعة من نوع $5 أمر سخيف من الناحية المالية؛ ساعات العمل تتجاوز تكلفة المكون. لكن بالنسبة إلى وحدة Virtex UltraScale+ بقيمة $15,000، فإن إعادة التعبئة إلزامية. تتضمن العملية قالبًا محددًا يطابق مساحة الرقاقة، ومواد لاصقة لزجة، وآلاف من كرات اللحام المجهزة مسبقًا (غالبًا بقطر 0.4 مم أو 0.5 مم) التي تصب يدويًا وتُوازن.
لكن عدم اليقين لا مفر منه. في كل مرة يخضع فيها دي آي سي من السيليكون لدورة تدفق حراري — التسخين إلى 240°C والتبريد — يتراكم الضغط الحراري. يتسبب عدم التطابق في التمدد الحراري بين دي آي السيليكون، وركيزة الحزمة، ولوحة الدوائر المطبوعة في فرض قوة على الوصلات الداخلية. عادةً ما يتحمل الرقاقة دورة تدفق حرارية أو اثنتين (التجميع الأولي، الإزالة، إعادة التعبئة، الوضع) — ولكن الجودة لا تُضمن أبدًا. يمكننا تقليل المخاطر باستخدام تحديد الملف المثالي، لكن لا يمكننا تغيير حد التعبئة للمواد.
يعتمد قرار إعادة العمل غالبًا على نسبة «الاستبدال مقابل الاسترداد». إذا كانت السيليكون لا يمكن استبداله بسبب نقص المكونات، أو إذا كانت اللوحة تمثل أسابيع من وقت التصنيع الفريد، فإن الاستثمار في ملف حراري مناسب ووقت عامل ماهر يعتبر ضئيلًا مقارنة بتكلفة البدء من جديد. تتوفر المعدات — سخانات ما قبل، أنظمة الرؤية، رؤوس التدفق المعزولة بالنيتروجين — لتحويل كارثة إلى تأخير هندسي قياسي.
