Het scenario is frustrerend algemeen. Een complexe PCB, dicht met zware koperen vlakken, komt uit de reflowovens. Inspectie toont een cluster van head-in-pillow (HiP) defecten onder een grote BGA—sluwe open circuits waar het soldeerballetje en de pasta niet samenkwamen. Het onmiddellijke instinct is het verhogen van de hoeveelheid soldeerpasta. Het lijkt logisch: als de verbinding niet vormt, voeg gewoon meer materiaal toe.

Dit instinct is verkeerd. Bij Bester PCBA hebben we dit benadering keer op keer zien falen. Voor hoog thermisch massieve assemblages negeert het overladen van de pads met pasta de ware boosdoener. Het probleem is geen gebrek aan soldeer; het is een tijdelijke, catastrofale verlies van coplanariteit gedreven door de fysica van warmteoverdracht. De oplossing ligt niet in een grotere stencilopening, maar in een gedisciplineerde controle van je hele assemblageproces.
De Anatomie van een koppige defect: Warping, thermische vertraging en gefaalde intuïtie
Een printed circuit board is geen inert blad. Het is een samenstelling van materialen met heel verschillende thermische eigenschappen. Wanneer een board met aanzienlijk thermisch massa uit zware groundplanes of een dik formulierplaten in een reflowoven komt, weerstaat het temperatuurverandering, wat zorgt voor de perfecte omstandigheden voor HiP-defecten.
De kernuitdaging van hoge thermische massa
Hoge thermische massa fungeert als een warmtewisselaar, wat een diepe thermische vertraging veroorzaakt. Terwijl de buitenranden en componenten op de bovenkant snel opwarmen, nemen de innerlijke lagen en grondvlakken aan de zijde van de componenten de thermische energie veel langzamer op. Deze differentiële verwarming is de motor achter dynamische warping tijdens de reflow. De PCB vervormt fysiek in de oven, en deze vervorming is noch uniform noch statisch.
Het ontkrachten van de mythes van 'Meer Pasta': Een probleem van timing, niet volume
Meer pasta toevoegen mislukt omdat het HiP als een eenvoudig gap-filling probleem behandelt. De ruimte is echter dynamisch. Een grotere pasta-afzetting kan inzakken, het risico op bridging vergroten, en nog steeds niet contact maken met een BGA-balletje dat tijdelijk is losgekomen door warping. De kernfaling is een mismatch in tijd: de soldeerpasta smelt en de fluxactiviteit is uitgeput net op het moment dat het BGA-balletje zich op het verste punt van reizen bevindt. Wanneer de PCB later in het profiel uitdijt, is de pasta een geoxideerde, niet-wetbare massa. De verbinding faalt omdat het contact niet werd gemaakt op het precieze moment van het vloeigetal—een probleem dat volume alleen niet kan oplossen.
Eerste principes: De fysica van coplanariteit drift
Om dit defect op te lossen, moet je de krachten die in werking zijn begrijpen. Het HiP-defect op een hoog thermisch massa PCB is het verhaal van een fysieke strijd tussen het component en de PCB, gevochten met het wapen van temperatuur.
De strijd der temperaturen: Hoe thermische gradiënten vervorming veroorzaken

Naarmate de assemblage door de reflow-oven gaat, ontwikkelt zich een significant temperatuurverschil, of delta-T, tussen thermisch lichte en zware gebieden. De BGA-verpakking, met haar lage thermische massa, wordt snel warm. Het gebied van de PCB direct onder de BGA, vaak verbonden met een massief aardvlak, wordt veel langzamer verwarmd. Dit delta-T veroorzaakt differentiële uitzetting. De BGA zet sneller uit dan het onderliggende bord, wat leidt tot een ‘lachende’ vervorming waarbij het midden van de component zich van de PCB tilt. Dit creëert de fysieke scheiding die de head-in-pillow-voorwaarde definieert.
De BGA versus Het Bord: Een Race naar Liquidus
Deze vervorming is het ernstigst tijdens de ramp-naar-piek fase van het reflowprofiel—cruciaal is dat dit ook het moment is waarop het soldeerleger haar liquidustemperatuur bereikt. De soldeerballen van de BGA, die snel zijn opgewarmd, zijn gesmolten en klaar om een verbinding te vormen. De soldeerpasta op de PCB-pad daarentegen, heeft nog moeite om de temperatuur te bereiken vanwege de thermische vertraging van het bord. Het resultaat is een kritieke misuitlijning. De BGA-bal is vloeibaar, maar de pasta is nog niet volledig gesmolten of de ruimte die door vervorming is ontstaan, is te groot om te overbruggen voordat de flux op is. De verbinding faalt.
Het Thermisch Playbook: De Reflow-profilering beheersen
Aangezien de oorzaak thermisch is, moet de oplossing dat ook zijn. Jouw reflowprofiel is het krachtigste hulpmiddel om dynamische vervorming te beperken. Het doel is niet alleen het smelten van soldeer, maar het beheren van de delta-T over de hele assemblage, zodat alles tegelijk en op hetzelfde vlak de liquidus bereikt.
Het verlengen van de Soak voor Thermisch Evenwicht
Voor borden met hoge thermische massa is een langere en beter gecontroleerde soak-zone onmisbaar. Een typisch korte soak-profiell dat werkt voor eenvoudige borden, zou hier rampzalig zijn. Een verlengde soak-periode net onder het smeltpunt van het soldeer laat de hardnekkige, thermisch zware gebieden van het bord ‘bijbenen’ bij de lichtere gebieden. Door de delta-T over de gehele assemblage te minimaliseren... voordat de uiteindelijke ramp naar piek, vermindert u drastisch de drijfkracht achter vervorming. De montage betreedt de kritieke piekzone in een staat van thermisch evenwicht.
Gedisciplineerde Tijd-Boven-Liquidus: Vlakke Verbindingen Maken
Eenmaal in evenwicht is de tijd-boven-liquidus (TAL) de volgende kritieke parameter. Een veelgemaakte fout is een TAL dat te kort is, wat volledige natheid verhindert, of te lang, wat componenten verslechtert en flux uitgeput. Voor HiP is het doel een TAL net lang genoeg zodat twee dingen kunnen gebeuren: dat het gesmolten soldeer volledig versmelten, en dat de PCB en component zich ‘ontspannen’ in een meer vlakke toestand terwijl de temperaturen gelijkmaken bij de piek. Deze discipline smeedt een vlakke, stevige verbinding. Voor degenen met ovens die minder verwarmingszones hebben, kan het bereiken van een lange, stabiele soak uitdagend zijn. In deze gevallen kan een langzamer algeheel ramp-tarief een langere soak simuleren, waardoor de PCB meer tijd krijgt om te gelijk te worden zelfs als dit de totale profielduur verlengt.
Voorbij het profiel: Mechanische en materiaalaanpassingen
Terwijl het thermische profiel de sterspeler is, bieden twee andere ingrepen een volledige, robuuste oplossing door de fysieke en chemische aspecten van het probleem aan te pakken.
Het Temmen van het Bord met Juiste Ondersteuning
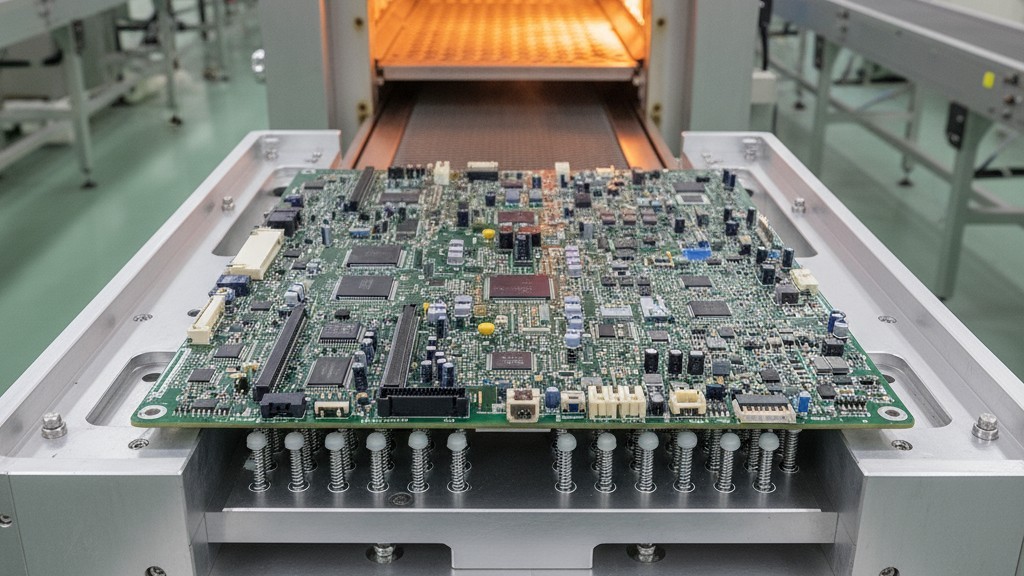
Als thermische gradiënten de motor van vervorming zijn, is het gebrek aan fysieke ondersteuning wat deze laat doorlopen. Borden met hoge thermische massa, vooral grote of dunne, moeten goed worden ondersteund in de oven. Relying op eenvoudige randtransporteurs is niet voldoende. We raden sterk aan te investeren in speciale ondersteuningsfixtures met pinnen die contact maken met de rand en het midden van het bord, vooral rond de BGA. Deze mechanische ondersteuning beperkt fysiek de PCB, bestrijdt haar neiging tot vervorming en verbetert de coplanariteit aanzienlijk.
Je Wapen Kiezen: Hoge-Tack, Lage-Slump Soldeerpasta
De soldeerpasta zelf is een actieve deelnemer. Bij HiP op deze borden is de chemie van de pasta cruciaal. Je hebt een pasta nodig met uitzonderlijke tackiness en een krachtig fluxpakket. Een high-tack pasta zorgt ervoor dat, zelfs als er kleine scheidingen ontstaan, er fysiek contact blijft met de BGA-bal. De flux moet zo ontworpen zijn dat hij een langer weekprofiel kan doorstaan zonder activiteit te verliezen, klaar om oxides te reinigen zodra liquidus wordt bereikt. Een pasta met slechte slump-prestaties of een zwakke flux zal het alleen maar erger maken.
Het controleren van de oplossing: Van procescontrole tot röntgenstraling

Het implementeren van deze veranderingen is het halve werk; het verifiëren van hun succes is het andere halve. Consistente thermische profilering is essentieel om ervoor te zorgen dat je proces onder controle blijft. Een succesvolle, gedocumenteerde profiel dat HiP elimineert, moet regelmatig worden gecontroleerd.
Uiteindelijk komt het definitieve bewijs uit inspectie. Hoewel visuele inspectie aanwijzingen kan geven, is de enige manier om zeker te weten dat HiP is geëlimineerd via geautomatiseerde röntgeninspectie (AXI). Het dwarsdoorsnedezicht van een X-ray toont duidelijk een volledig samengevoegde, homogene soldeerverbinding, waardoor wordt bevestigd dat je gedisciplineerde, procesgerichte aanpak heeft geslaagd waar het simpelweg toevoegen van meer pasta gedoemd was te mislukken.
