Skenario ini sangat umum dan frustasi. Sebuah papan kompleks, penuh dengan perang copper berat, muncul dari oven reflow. Pemeriksaan menunjukkan sekumpulan cacat head-in-pillow (HiP) di bawah BGA besar—sirkuit terbuka yang licik di mana bola solder dan pasta gagal menyatu. Naluri langsung adalah meningkatkan volume pasta solder. Tampaknya logis: jika sambungan tidak terbentuk, cukup tambahkan lebih banyak bahan.

Naluri ini salah. Di PCBA Bester, kami telah melihat pendekatan ini gagal berulang kali. Untuk rakitan dengan massa termal tinggi, membanjiri pad dengan pasta mengabaikan penyebab sebenarnya. Masalahnya bukan kekurangan solder; tetapi kehilangan koplanaritas secara sementara dan katastrofik yang dipicu oleh fisika transfer panas. Solusinya tidak terletak pada aperture stencil yang lebih besar, tetapi dalam pengendalian disiplin dari seluruh proses perakitan Anda.
Anatomi Cacat Keras: Warpage, Keterlambatan Termal, dan Intuisi yang Gagal
Papan sirkuit tercetak bukanlah balok inert. Ini adalah komposit bahan dengan sifat termal yang sangat berbeda. Ketika papan dengan massa termal yang signifikan dari tanah besar atau bentuk tebal memasuki oven reflow, ia menolak perubahan suhu, menciptakan kondisi sempurna untuk cacat HiP.
Tantangan Inti dari Massa Termal Tinggi
Massa termal tinggi bertindak sebagai pendingin panas, menyebabkan keterlambatan termal yang mendalam. Sementara tepi luar papan dan komponen di sisi atas memanas dengan cepat, lapisan dalam dan tanah di sisi komponen menyerap energi panas jauh lebih lambat. Perbedaan pemanasan ini adalah mesin yang menggerakkan warpage dinamis selama reflow. Papan secara fisik menyusut di oven, dan distorsi ini tidak seragam ataupun statis.
Membongkar mitos “Lebih Banyak Pasta”: Masalah Waktu, Bukan Volume
Menambahkan lebih banyak pasta gagal karena memperlakukan cacat HiP sebagai masalah pengisian celah yang sederhana. Namun, celahnya bersifat dinamis. Deposito pasta yang lebih besar dapat melorot, meningkatkan risiko jembatan, dan tetap gagal menyentuh bola BGA yang secara sementara terangkat karena warpage. Kegagalan utama adalah ketidakselarasan dalam waktu: pasta solder meleleh dan aktivitas fluksnya habis tepat saat bola BGA berada pada titik terjauh perjalanannya. Saat papan melurus nanti dalam profil, pasta tersebut menjadi massa yang teroksidasi dan tidak basah. Sambungan gagal karena kontak tidak dibuat pada saat liquidus—masalah yang volume saja tidak dapat menyelesaikan.
Prinsip Dasar: Fisika Drifting Coplanarity
Untuk mengatasi cacat ini, Anda harus memahami kekuatan yang sedang berperang. Cacat HiP pada papan dengan massa termal tinggi adalah kisah tentang pertarungan fisik antara komponen dan PCB, yang dipertarungkan dengan senjata suhu.
Pertempuran Suhu: Bagaimana Gradien Termal Menggerakkan Warpage

Saat perakitan melewati oven reflow, terjadilah perbedaan suhu yang signifikan, atau delta-T, antara area yang ringan dan berat secara termal. Paket BGA, dengan massa termal yang rendah, memanas dengan cepat. Area PCB di bawahnya, yang sering dikaitkan dengan tanah yang besar, memanas jauh lebih lambat. Delta-T ini menyebabkan ekspansi diferensial. BGA mengembang lebih cepat daripada papan di bawahnya, menyebabkan warpage 'senyum' di mana pusat komponen terangkat dari PCB. Ini menciptakan pemisahan fisik yang mendefinisikan kondisi head-in-pillow.
BGA vs. Papan: Perlombaan Menuju Liquidus
Warpage ini paling parah selama tahap ramp-to-peak dari profil reflow—yang penting, ini juga saat paduan solder mencapai suhu liquidus-nya. Bola solder BGA, yang memanas dengan cepat, mencair dan siap membentuk sambungan. Pasta solder di pad PCB, bagaimanapun, masih berjuang mencapai suhu karena keterlambatan termal papan. Hasilnya adalah ketidaksesuaian kritis. Bola BGA cair, tetapi pasta belum sepenuhnya cair atau celah yang dibuat oleh warpage terlalu besar untuk dijembatani sebelum flux habis. Sambungan gagal.
Buku Pedoman Termal: Menguasai Profil Reflow
Karena penyebab utamanya adalah thermal, solusinya juga harus thermal. Profil reflow Anda adalah alat paling ampuh untuk mengurangi warpage dinamis. Tujuannya bukan hanya melelehkan solder, tetapi mengelola delta-T di seluruh rakitan, memastikan semuanya mencapai liquidus pada waktu yang sama dan pada bidang yang sama.
Memperpanjang Soak untuk Keseimbangan Termal
Untuk papan dengan massa termal tinggi, zona soak yang lebih lama dan dikendalikan dengan hati-hati adalah hal yang tak bisa dinegosiasikan. Profil soak singkat yang biasanya cocok untuk papan sederhana akan menjadi bencana di sini. Periode soak yang diperpanjang tepat di bawah titik leleh solder memungkinkan area yang keras kepala dan berat secara termal pada papan untuk 'mengejar' area yang lebih ringan. Dengan meminimalkan delta-T di seluruh rakitan sebelum ramp terakhir menuju puncak, Anda secara drastis mengurangi gaya pendorong di balik warpage. Rakitan memasuki zona puncak yang kritis dalam keadaan keseimbangan termal.
Waktu-Teratas-Liquidus yang Disiplin: Membentuk Sambungan Datar
Setelah dalam keadaan seimbang, waktu-diatas-liquidus (TAL) adalah parameter kritis berikutnya. Kesalahan umum adalah TAL yang terlalu singkat, mencegah perlekatan penuh, atau terlalu lama, yang merusak komponen dan menghabiskan flux. Untuk HiP, tujuan adalah TAL yang cukup lama agar dua hal terjadi: agar solder cair sepenuhnya menyatu, dan agar papan dan komponen 'relaks' ke keadaan yang lebih planar saat suhu menyamai puncaknya. Disiplin ini membentuk sambungan yang datar dan kuat. Bagi mereka yang menggunakan oven dengan zona pemanasan yang lebih sedikit, mencapai soak yang panjang dan stabil bisa menjadi tantangan. Dalam kasus ini, laju kenaikan yang lebih lambat secara keseluruhan dapat mensimulasikan soak yang lebih lama, memberikan waktu lebih bagi papan untuk menyamakan suhu meskipun memperpanjang waktu keseluruhan profil.
Lebih dari Sekadar Profil: Intervensi Mekanis dan Material
Meskipun profil termal adalah pemain utama, dua intervensi lain memberikan solusi lengkap dan kuat dengan mengatasi aspek fisik dan kimia dari masalah tersebut.
Mengendalikan Papan dengan Dukungan yang Tepat
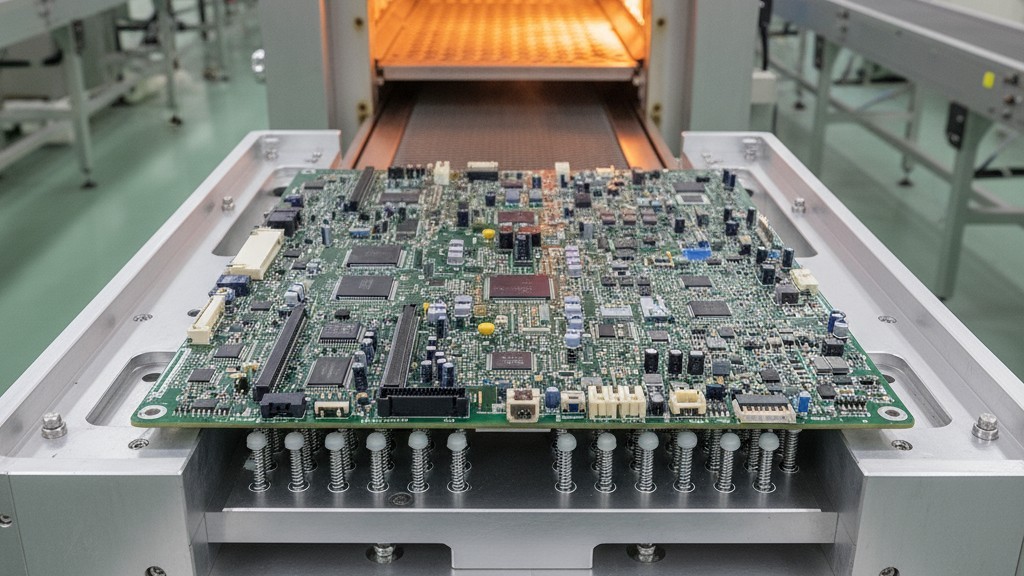
Jika gradien thermal adalah mesin utama warpage, kekurangan dukungan fisik adalah apa yang membiarkannya berjalan liar. Papan dengan massa termal tinggi, terutama yang besar atau tipis, harus didukung dengan benar di dalam oven. Mengandalkan konveyor tepi sederhana tidak cukup. Kami sangat menyarankan perangkat dukungan khusus dengan pin yang bersentuhan dengan papan di tepi dan di tengah, terutama di sekitar BGA. Dukungan mekanis ini secara fisik membatasi papan, melawan kecenderungannya untuk melengkung dan secara dramatis meningkatkan koplanaritas.
Memilih Senjata Anda: Pasta solder berstik tinggi, rendah slump
Lem kulit solder sendiri adalah peserta aktif. Saat menghadapi HiP di papan ini, kimia pasta sangat penting. Anda memerlukan pasta dengan daya rekat yang luar biasa dan paket fluks yang kokoh. Pasta dengan daya rekat tinggi memastikan bahwa bahkan jika terjadi pemisahan kecil, tetap menjaga kontak fisik dengan bola BGA. Fluks harus dirancang agar tahan terhadap profil rendaman yang lebih lama tanpa kehilangan aktivitas, siap membersihkan oksida segera saat liquidus tercapai. Pasta dengan performa slump yang buruk atau fluks yang lemah akan membuat segalanya menjadi lebih buruk.
Memverifikasi Perbaikan: Dari Kontrol Proses ke X-Ray

Melaksanakan perubahan ini adalah setengah dari perjuangan; memverifikasi keberhasilannya adalah setengah lainnya. Profil termal yang konsisten sangat penting untuk memastikan proses Anda tetap terkendali. Profil yang berhasil dan terdokumentasi dengan baik yang mengeliminasi HiP harus diaudit secara teratur.
Akhirnya, bukti definitif berasal dari inspeksi. Sementara inspeksi visual dapat memberikan petunjuk, satu-satunya cara untuk memastikan bahwa HiP telah dihilangkan adalah melalui inspeksi sinar-X otomatis (AXI). Tampilan potongan melintang dari sinar-X akan dengan jelas menunjukkan sambungan solder yang benar-benar menyatu dan homogen, memastikan bahwa pendekatan disiplin dan berorientasi proses Anda telah berhasil di mana menambahkan lebih banyak pasta saja pasti gagal.
