Dasar regulasi telah bergeser. Bertahun-tahun, solder berisi timbal dalam paket array bola grid (BGA) menikmati masa tenggang di bawah pengecualian RoHS, dibenarkan oleh tantangan teknis yang besar dalam peralihan komponen berperforma tinggi ke alternatif tanpa timbal. Jendela waktu itu sekarang menutup. Pengecualian yang memperbolehkan solder timbal-tin dalam BGA untuk aplikasi tertentu akan berakhir di pasar utama, memaksa tim perangkat keras beralih ke migrasi tanpa timbal. Ini bukan kekhawatiran yang jauh. Timeline-nya dipadatkan, dan implikasinya melampaui sekadar memenuhi kotak kepatuhan.
Peralihan dari BGA berisi timbal ke yang tanpa timbal adalah kejadian keandalan, bukan latihan administrasi dokumen. Ilmu material dasar telah berubah. Perilaku sambungan solder di bawah tekanan termal dan mekanis, pertumbuhan intermetallics, mode kegagalan utama—semuanya berbeda. Tim yang terbiasa dengan kinerja ductile yang dapat diprediksi dari solder eutektik timbal-tin kini harus menavigasi dunia yang lebih keras, rapuh, dan ber suhu tinggi dari paduan SAC. Asumsi bahwa tanpa timbal adalah pengganti langsung sangat salah dan telah menyebabkan kegagalan lapangan di mana perancang meremehkan pergeseran.
Tantangan teknis diperparah oleh kompleksitas operasional. Rantai pasokan harus bertransisi bersamaan dengan desain. Prosedur rework dan perbaikan memerlukan profil suhu baru dan pelatihan operator. Timeline pengujian validasi memanjang karena data keandalan untuk rakitan berisi timbal tidak dapat langsung dipindahkan. Untuk produk dengan siklus kualifikasi multi-tahun di industri penerbangan, medis, atau otomotif, tekanan sangat tinggi. Penundaan dalam memulai peralihan dapat berakibat hilangnya jendela sertifikasi dan akses pasar.
Di PCBA Bester, kami telah membimbing tim melalui transisi ini di berbagai industri, dan pola ini konsisten. Keberhasilan bergantung pada pemahaman dasar tentang perbedaan material, diikuti oleh rencana metodis yang mengatasi desain, pasokan, manufaktur, dan validasi secara bersamaan. Tim yang menganggap ini sebagai substitusi kecil menghadapi redesain biaya tinggi dan peluncuran yang tertunda. Mereka yang menganggap ini sebagai program rekayasa keandalan skala penuh menavigasi transisi ini dengan risiko terkendali.
Jendela Pembebasan Mendekat
Direktif RoHS asli melarang timbal di sebagian besar elektronik, tetapi memberikan pengecualian tertentu untuk aplikasi di mana pengganti tanpa timbal menimbulkan risiko teknis. Solder berisi timbal dalam BGA berperforma tinggi termasuk dalam kategori ini, terutama untuk komponen dalam infrastruktur telekomunikasi, perangkat medis, dan kontrol industri di mana integritas sambungan solder adalah misi krusial. Pengecualian ini mengakui bahwa paduan tanpa timbal kurang data lapangan selama puluhan tahun yang dimiliki solder timbal-tin.
Pengecualian tersebut kini berakhir. Uni Eropa telah menetapkan tanggal akhir yang jelas, dengan garis waktu penegakan yang memberi sedikit waktu bagi perusahaan yang masih merancang dengan komponen berisi timbal. Pengecualian 7(c)-I, misalnya, berakhir pada 2021 untuk sebagian besar kategori. Pasar lain, termasuk China, Jepang, dan Korea Selatan, mengikuti trajektori serupa. Meskipun timeline-nya tersebar, niatnya seragam: lingkungan regulasi semakin ketat secara global, dan justifikasi teknis untuk penggunaan berisi timbal terus menghilang.
Implikasi praktisnya adalah tenggat waktu yang ketat. Produk yang dipasarkan setelah pengecualian berakhir harus tanpa timbal atau menghadapi pembatasan akses pasar, denda, dan penolakan rantai pasok. Untuk tim perangkat keras, produk apa pun yang sedang dikembangkan harus mempertimbangkan transisi ini. Waktunya terus berjalan.
Mengapa Komposisi Alloy Bukan Detail Kecil
Menghadapi tenggat waktu ini, nalurinya adalah menganggap transisi sebagai pertukaran bahan sederhana: mengganti BGA berisi timah dengan yang setara bebas timah, menyesuaikan profil reflow, dan melanjutkan. Naluri ini telah menyebabkan kegagalan yang dapat dicegah dalam produk yang telah digunakan di lapangan. Perbedaan antara paduan eutektik timah- timbal dan paduan SAC yang bebas timah bukanlah catatan kaki dalam lembar data; ini adalah perubahan mendasar dalam bagaimana sambungan solder terbentuk, merespons stres, dan memburuk seiring waktu.
Paduan tanpa timbal—biasanya terdiri dari timbal, perak, dan tembaga (SAC)—lebih keras, lebih rapuh, dan memerlukan suhu reflow yang lebih tinggi. Ini memberikan beban termal tambahan pada papan, paket komponen, dan semua bahan di sekitarnya. Senyawa intermetallic yang terbentuk di antarmuka solder-ke-pad berkembang lebih cepat dan menunjukkan karakteristik patahan yang lebih rapuh. Ini bukan kasus pinggiran; mereka adalah perilaku utama yang menentukan apakah sambungan solder bertahan sepuluh tahun di lingkungan keras atau gagal dalam tiga tahun.
Implikasi rantai pasok sama mendesaknya. Produsen komponen sedang menghentikan BGA berisi timbal seiring permintaan bergeser. Distributor mengelola transisi inventaris, membuat waktu tunggu untuk bagian berisi timbal menjadi tidak menentu. Menunggu hingga saat terakhir berisiko menemukan komponen pilihan Anda tidak lagi tersedia dalam versi berisi timbal, memaksa redesain tak terduga dengan tekanan waktu yang ekstrem.
Jadwal validasi memperkenalkan batasan terakhir. Produk yang memenuhi syarat dengan solder berisi timah tidak dapat mengasumsikan keandalan yang setara tanpa pengujian baru. Uji umur dipercepat, siklus termal, dan protokol getaran harus diulang karena mode kegagalan tidak identik. Untuk industri dengan sertifikasi ketat, ini bisa berarti enam hingga dua belas bulan pekerjaan validasi tambahan. Untuk tim yang menunda, tabrakan antara jadwal ini dan tenggat waktu pasar menjadi krisis.
Ilmu Material dari Sambungan Lain Tanpa Timbal
Kesenjangan performa dimulai dari paduan itu sendiri. Eutektik timah- timbal (63/37), standar industri selama beberapa dekade, mencair pada 183°C dan membentuk sambungan yang mampu ditekuk. Paduan SAC bebas timbal seperti SAC305 mencair di sekitar 217°C. Perbedaan 34 derajat ini mendorong suhu puncak reflow ke kisaran 240-250°C, yang berarti tegangan termal yang lebih besar pada setiap material dalam rakitan.

Suhu yang lebih tinggi tersebut membebani substrat PCB. Laminat FR-4 standar mengembang lebih banyak, berisiko kerusakan warping dan delaminasi, terutama pada papan dengan komponen padat atau lapisan tembaga tebal. Paket komponen itu sendiri juga mengalami tekanan yang lebih tinggi. Campuran pencetakan dan bahan perekat die dikenai perubahan suhu yang mungkin tidak dirancang untuknya.
Suhu Reflow yang Lebih Tinggi dan Tegangan Mekanis
Kenaikan suhu secara langsung berakibat pada mekanis. Ketidaksesuaian ekspansi termal antara paket BGA, bola solder, dan pad PCB menjadi lebih nyata. Tegangan yang dapat dikelola dengan reflow timah- timbal kini dapat menghasilkan kekuatan cukup untuk memecahkan sambungan solder atau deformasi komponen. BGA besar sangat rentan, karena baris luar dari bola solder mengalami tegangan mekanis tertinggi selama siklus termal.
Ini membatasi pilihan bahan papan. Laminat suhu tinggi sering menjadi keharusan untuk menangani beban termal. Finishing permukaan juga harus dipertimbangkan kembali, karena opsi umum seperti OSP dapat berperilaku berbeda di profil bebas timbal. Enam pelindung emas nikel tanpa elektrolit (ENIG) tetap menjadi pilihan yang andal, tetapi pengendalian ketebalannya menjadi lebih kritis untuk menghindari pembentukan intermetallic rapuh. Margin termal, yang sebelumnya nyaman dalam proses berisi timbal, menyusut. Perancang harus memperhitungkan ruang kepala yang berkurang antara puncak reflow dan suhu maksimum yang diizinkan untuk komponen sensitif seperti osilator atau konektor.
Pembentukan Senyawa Intermetallic dan Keandalan Jangka Panjang
Senyawa intermetallic (IMC) terbentuk di antarmuka solder-tembaga selama reflow, menciptakan ikatan metallurgi yang membuat sambungan menjadi andal. Yang penting bukan keberadaannya, tetapi komposisinya, laju pertumbuhannya, dan perilakunya seiring waktu. Solder bebas timbal menghasilkan IMC yang berbeda dari timah- timbal, dan perbedaan tersebut sangat penting untuk keandalan jangka panjang.
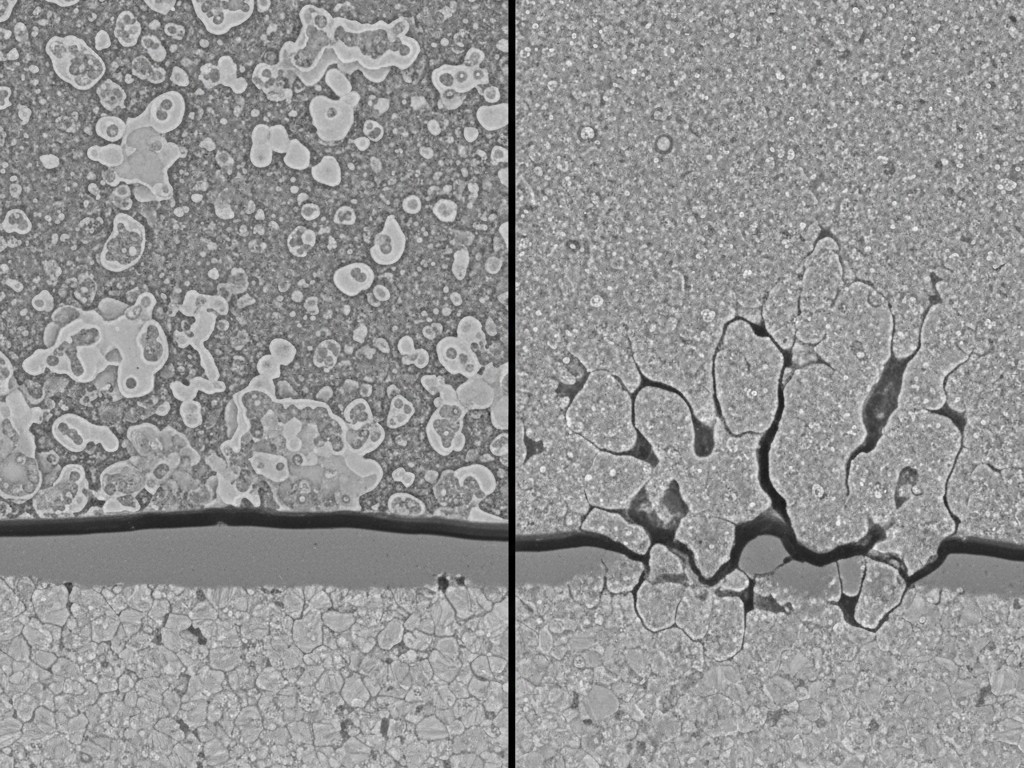
Dalam sambungan timah- timbal, IMC dominan adalah fase yang relatif duktile. Pada sambungan SAC bebas timbal, IMC utama yang sama terbentuk, tetapi pertumbuhannya dipercepat oleh suhu yang lebih tinggi dan tidak adanya timbal, yang berfungsi sebagai penghambat pertumbuhan. Fase IMC kedua yang jauh lebih rapuh juga dapat berkembang, terutama selama penuaan suhu tinggi atau siklus reflow yang berulang.
Siklus termal mempercepat pertumbuhan ini. Setiap perubahan suhu menebalkan lapisan intermetallic, menciptakan bidang kelemahan di antarmuka solder-pad. Di bawah tegangan siklik, retak mulai terbentuk dan menyebar melalui lapisan IMC yang rapuh ini daripada melalui solder massal. Mode kegagalan ini, yang kurang umum pada sambungan timah- timbal, berarti solder bebas timbal dapat menunjukkan umur kelelahan termal yang lebih pendek di lingkungan yang keras. Untuk produk keandalan tinggi dengan harapan umur lapangan 15 atau 20 tahun, pergeseran distribusi kegagalan ini harus dipahami dan divalidasi.
Realitas Rework dan Perbaikan Berubah
Rework adalah tempat suhu meningkat menjadi nyata dengan kejam. Menghapus BGA berisi timbal bisa dilakukan dengan suhu puncak sekitar 220-230°C. Rework bebas timbal membutuhkan puncak dekat 260°C atau lebih untuk melakukan reflow solder SAC secara penuh. 30-40°C tambahan ini membawa rakitan hampir mendekati ambang kerusakan untuk banyak bahan papan dan komponen yang berdekatan.
Risiko kerusakan papan melonjak tajam. Delaminasi dan pengelupasan pad menjadi jauh lebih sering, karena kekuatan adhesi pad tembaga memburuk di bawah paparan suhu tinggi yang berkepanjangan. Setelah pad terangkat, papan sering dianggap sebagai sampah kecuali perbaikan jumper wire secara luas dapat diterima—yang jarang terjadi dalam aplikasi keandalan tinggi.
Ketrampilan operator dan peralatan kini menjadi lebih penting. Margin kesalahan sangat tipis; overheating menyebabkan kerusakan, sementara underheating menghasilkan sambungan dingin. Teknisi rework yang terlatih pada proses berisi timbal perlu dilatih ulang, dan peralatan lama mungkin tidak memiliki ruang kepala termal atau presisi untuk pekerjaan bebas timbal yang andal. Pelayanan lapangan menambah lapisan kompleksitas. Mencampurkan solder berisi timbal dan tanpa timbal tidak disarankan, yang berarti tim layanan harus menyimpan suku cadang warisan berisi timbal atau mengesahkan proses rework penuh tanpa timbal untuk papan yang tidak dirancang untuk menahannya. Kedua opsi tidaklah sederhana.
Membangun Rencana Peralihan yang Kokoh
Peralihan ke BGAs bebas timbal adalah program lintas fungsi yang menyentuh desain, rantai pasokan, manufaktur, dan validasi. Keberhasilan memerlukan ketelitian yang sama seperti pengenalan produk baru.
Desain dan Seleksi Komponen
Tinjauan desain harus dimulai dengan analisis margin thermal. Apakah papan dapat menahan suhu reflow yang lebih tinggi? Simulasi termal dapat mengidentifikasi area berisiko, tetapi jika tumpukan yang ada tidak cukup, mungkin perlu desain ulang dengan laminasi Tg yang lebih tinggi. Pemilihan komponen harus memprioritaskan bagian dengan keturunan bebas timbal yang tangguh dan data keandalan yang terbukti. Tidak semua BGA bebas timbal dibuat sama. Akhirnya, kombinasi finishing pad papan dan paduan bola BGA harus dikonfirmasi melalui pengujian, bukan asumsi.
Koordinasi Rantai Pasokan dan Strategi Persediaan
Libatkan pemasok sejak dini. Mereka membutuhkan visibilitas terhadap garis waktu transisi Anda untuk mengelola persediaan dan produksi mereka. Waktu tunggu untuk komponen bebas timbal mungkin berbeda, dan memastikan komitmen pasokan sangat penting untuk mencegah kekurangan mendadak. Sumber ganda menjadi lebih kompleks, karena mungkin memerlukan rekwalifikasi kedua pemasok dengan penawaran bebas timbal mereka. Waktu inventaris adalah tindakan penyeimbangan antara memesan pembelian terakhir dari bagian berisi timbal—yang berisiko menjadi stok usang—dan memesan terlalu sedikit, berisiko mengalami situasi line-down.
Kualifikasi Proses Manufaktur
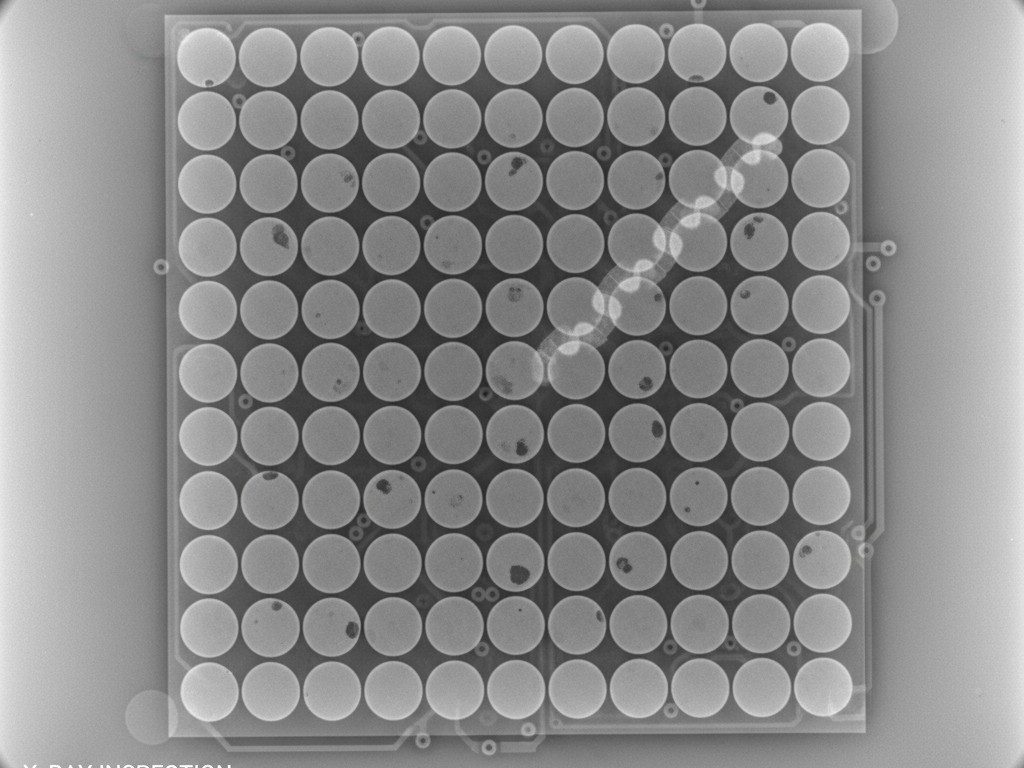
Pengembangan profil reflow adalah tugas pertama. Profil harus dioptimalkan untuk paduan SAC spesifik dan massa thermal papan, dengan menggunakan termokopel pada rakitan nyata untuk memverifikasi suhu di lokasi kritis. Kriteria inspeksi juga harus berubah. Sistem inspeksi sinar-X dan inspeksi optik otomatis (AOI) perlu dikalibrasi ulang, karena penampilan sambungan bebas timbal yang diterima berbeda dari yang berisi timbal. Pembuatan artikel pertama, lengkap dengan analisis fisik destruktif, sangat penting untuk menyetel proses sebelum memulai produksi massal.
Pengujian Validasi yang Tidak Bisa Ditunda
Data kualifikasi yang ada untuk produk berisi timbal tidak dapat dipindahkan ke versi bebas timbal. Properti material, mode kegagalan, dan mekanisme degradasi semuanya berbeda. Pengujian keandalan harus diulang.
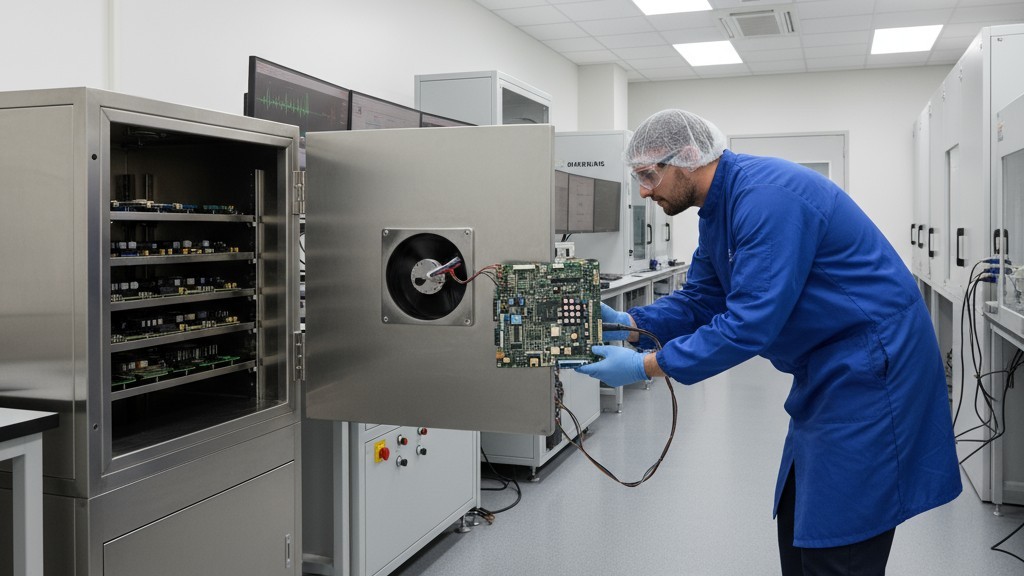
Pengujian yang diperlukan bergantung pada aplikasinya, tetapi siklus termal hampir selalu diperlukan. Mengikuti pedoman seperti IPC-9701, rakitan dikenai ratusan atau ribuan siklus suhu yang dipilih untuk mewakili lingkungan lapangan yang diharapkan. Pengujian getaran dan kejutan mekanis sangat penting untuk produk dalam lingkungan dinamis, karena sifat rapuh dari solder bebas timbal membuatnya merespons stress mekanis secara berbeda. Pengujian masa pakai yang sangat dipercepat (HALT) juga dapat digunakan untuk secara cepat menemukan kelemahan baru dalam desain.
Untuk produk di bidang medis, dirgantara, atau otomotif, proses validasi dan sertifikasi ini dapat memakan waktu satu tahun atau lebih. Memulai proses ini hanya setelah batas waktu diumumkan tidak memberi buffer untuk kegagalan atau desain ulang. Menunda validasi karena produk "terlihat berfungsi" adalah taruhan dengan keandalan lapangan dan akses pasar.
Mengelola Produk Legacy dan Inventaris Campuran
Produk yang sudah di lapangan menghadirkan tantangan unik. Melayani sistem yang menggunakan BGA berisi timbal memerlukan rencana untuk komponen pengganti. Setelah bagian berisi timbal tidak lagi diproduksi, Anda harus bergantung pada stok yang dihitung dengan hati-hati atau mengkwalifikasi proses perbaikan bebas timbal yang berisiko untuk papan warisan.
Di depot manufaktur dan layanan, segregasi inventaris yang ketat sangat penting untuk mencegah pencampuran tidak sengaja bagian berisi timbal dan bebas timbal. Komponen yang tidak cocok dapat menciptakan rakitan dengan perilaku dan keandalan yang tidak terduga. Pelabelan yang jelas dan kontrol proses diperlukan untuk menjaga ketertelusuran.
Akhirnya, pengurangan bertahap harus dikoordinasikan dengan siklus hidup produk. Untuk produk yang mendekati akhir masa pakainya, pembelian terakhir komponen berisi timbal mungkin pilihan yang pragmatis. Tetapi untuk produk apa pun yang masih memiliki sisa umur bertahun-tahun, transisi tidak dapat dihindari. Menunda hanya akan mempercepat garis waktu dan meningkatkan risiko.
Akhir dari pengecualian RoHS untuk BGA berlead bukanlah pembaruan regulasi yang kecil. Ini adalah fungsi paksaan yang akan mengekspos kelemahan dalam desain, ketahanan rantai pasokan, dan kontrol proses. Tim yang memulai lebih awal, memperlakukan transisi ini sebagai program rekayasa keandalan, dan memvalidasi asumsi mereka dengan data keras akan menavigasi perubahan ini. Mereka yang menunggu akan mendapati diri mereka bereaksi, membuat keputusan di bawah tekanan dengan informasi yang tidak lengkap. Jadwal sudah ditetapkan. Pilihannya adalah bagaimana menggunakannya.
