O silêncio de um protótipo morto é pesado. Não é apenas a falta de ruído do ventilador ou os LEDs escuros na interface de debug. É o cálculo imediato e afundador do custo. Quando uma placa de protótipo falha ao iniciar—talvez um BGA não tenha assentado corretamente durante a montagem, ou uma falha de design exija uma troca—o foco instantaneamente se reduz à grande quadrado preto no centro da PCB.

Em setores de alta confiabilidade, esse quadrado geralmente é um FPGA de alta qualidade, como um Xilinx Kintex UltraScale ou um Intel Stratix 10. Esses não são componentes comuns; são ativos. Em tempos de restrição na cadeia de suprimentos, substituir esse único chip pode envolver um prazo de entrega de 52 semanas ou uma margem de mercado de corretor que ultrapassa o orçamento do projeto. A própria placa, uma pilha de 12 camadas com vias cegas e enterradas, pode representar $5.000 em custos de fabricação e montagem. Retrabalhos não são reparos padrão. É uma operação de salvamento onde toda a linha do tempo do desenvolvimento está em jogo.
Física Não Negocia
Uma ideia errada perigosa persiste de que remover um Array de Grade de Bolas (BGA) é simplesmente uma questão de aplicar calor até o solda derreter. Essa atitude destrói protótipos. Pistolas de calor portáteis, embora excelentes para encolher tubos, são instrumentos de destruição para interconexões de alta densidade.
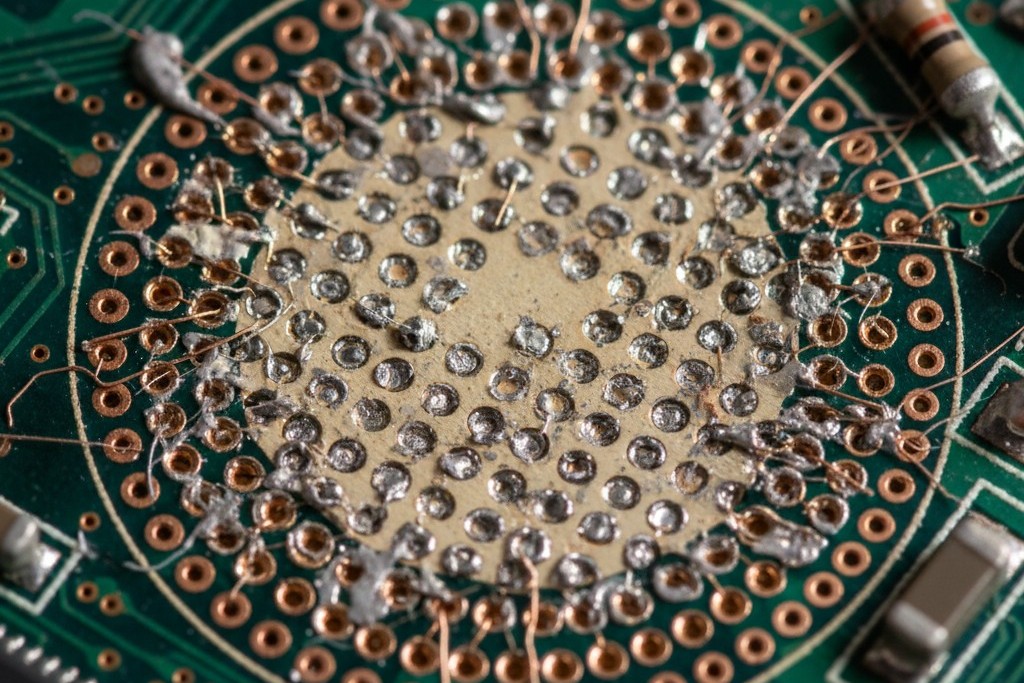
A física se resume à massa térmica e ao coeficiente de expansão térmica (CTE). Um FPGA moderno fica em uma placa cheia de planos de terra de cobre projetados especificamente para dissipar o calor. Se você bombardear a parte superior do chip com ar quente sem aquecer adequadamente a parte inferior da placa, você cria um gradiente térmico vertical. A parte superior se expande enquanto a inferior permanece fria e rígida. O resultado é deformação. À medida que a placa se curva, ela puxa contra as juntas de solda. Se a fonte de calor for descontrolada, você corre o risco de “craterar na almofada”—literalmente rasgar as almofadas de cobre do laminado de fibra de vidro. Uma vez que uma almofada é rasgada de uma trilha interna, a placa é inútil. Nenhum fio jumper pode consertar de forma confiável um par diferencial de alta velocidade operando a 10 Gbps.
Por isso, os engenheiros devem adotar uma mentalidade de “fabricação localizada”. O objetivo é reproduzir o perfil de reflow original—a curva específica de temperatura ao longo do tempo—que a placa viu no forno de fabricação. Toda a montagem deve ser levada até uma temperatura de imersão (geralmente entre 150°C a 170°C) para ativar o fluxo de solda e equalizar a temperatura por toda a PCB. Somente então você deve aplicar energia localizada ao componente para ultrapassar o ponto líquido de 217°C. A física ignora prazos; se a rampa térmica for muito acentuada, a umidade presa dentro do encapsulamento do chip se expande em vapor, causando delaminação ou “estouro de pipoca”. Um chip explodido é um chip morto.
O Processo: Intervenção Controlada
Salvar um componente de $2.000 exige rigor. O processo começa dias antes do retrabalho real com gerenciamento de umidade. A menos que a placa tenha sido armazenada em uma caixa seca com indicadores de umidade que mostram níveis seguros, ela deve ser assada. Protocolos padrão IPC-1601 ditam assar a umidade da PCB e do componente para evitar delaminação por pressão de vapor. Pular essa etapa é a causa mais comum de falhas invisíveis que aparecem semanas depois.
Depois que a placa estiver seca, ela passa a um sistema dedicado de retrabalho—normalmente uma máquina com óptica de visão dividida, pré-aquecedores infravermelhos na parte inferior e uma ponta de convecção superior controlada por computador. A automação conduz esse processo, não o tato manual. Um termopar é frequentemente conectado a uma placa sacrificial para traçar exatamente o perfil térmico. Precisamos saber que, quando a máquina marca 230°C, as bolas de solda sob o centro dessa grade de 35x35mm realmente atingem o reflow, não permanecem frias devido a um dissipador de calor próximo.
A remoção em si é anti climática se o perfil estiver correto. A ponta de vácuo desce, a solda liquefaz, e o componente levanta-se verticalmente com força zero. A ansiedade aumenta imediatamente após: a preparação do local. Isso envolve remover manualmente a solda antiga das almofadas da PCB usando ferro de solda e algodão de sarga. É aqui que as mãos do técnico importam mais. O ferro deve “flutuar” sobre as almofadas; qualquer pressão para baixo corre o risco de levantar uma almofada, o que geralmente é fatal para a placa. Embora existam métodos de reparo epóxi para almofadas levantadas, o desalinhamento de impedância introduzido por um reparo muitas vezes é inaceitável para linhas FPGA de alta frequência. As almofadas devem estar limpas, planas e brilhantes de cobre antes que um chip novo ou reballado possa ser colocado.
A Equação da Reballing

Às vezes, o objetivo não é um novo chip, mas recuperar o antigo de uma placa morta para usar em outro lugar, ou reinsere um chip que teve uma falha de conexão. Isso introduz a subdisciplina de reballing. Um BGA removido tem protuberâncias de solda desordenadas e irregulares na parte de baixo. Estas devem ser removidas com cuidado e novas esferas de solda aferidas.
É um cálculo de ROI puro. Reballing de um microcontrolador de commodities $5 é um absurdo financeiro; as horas de trabalho excedem o custo do componente. Mas para um Virtex UltraScale+ avaliado em $15.000, o reballing é obrigatório. O processo envolve uma máscara específica que combina com a pegada do chip, um fluxo pegajoso e milhares de esferas de solda pré-formadas (geralmente de 0,4mm ou 0,5mm de diâmetro) despejadas e alinhadas manualmente.
A incerteza, no entanto, é inevitável. Toda vez que um die de silício passa por um ciclo de reflow—aquecimento a 240°C e resfriamento—o estresse térmico se acumula. A incompatibilidade na expansão térmica entre o die de silício, o substrato da embalagem e a PCB exerce força sobre as conexões internas. Embora geralmente um chip possa suportar duas ou três ciclos de reflow (montagem inicial, remoção, reballing, colocação), a produtividade nunca é garantida. Podemos mitigar o risco com um perfil perfeito, mas não podemos alterar o limite de fadiga dos materiais.
A decisão de retrabalhar geralmente se resume à relação 'substituir vs. recuperar'. Se o silício for insubstituível devido a escassez, ou se a placa representar semanas de tempo de fabricação único, o investimento em um perfil térmico adequado e tempo de operadores qualificados é insignificante em comparação ao custo de recomeçar. Os equipamentos—pré-aquecedores, sistemas de visão, cabeças de reflow a nitrogênio—existem para transformar uma catástrofe em um atraso de engenharia padrão.
