物理學對你的專案期限漠不關心。它不在乎你的材料清單目標,當然也不在乎你通過省略次級鍍層循環節省了二十美分每塊電路板。當你在元件墊內放置通孔——現代密度經常要求這樣做——你就創造了一個壓力容器。若像處理普通通孔那樣隨意對待這個容器,你就在最昂貴的硅晶片正下方建了一顆微型炸彈。
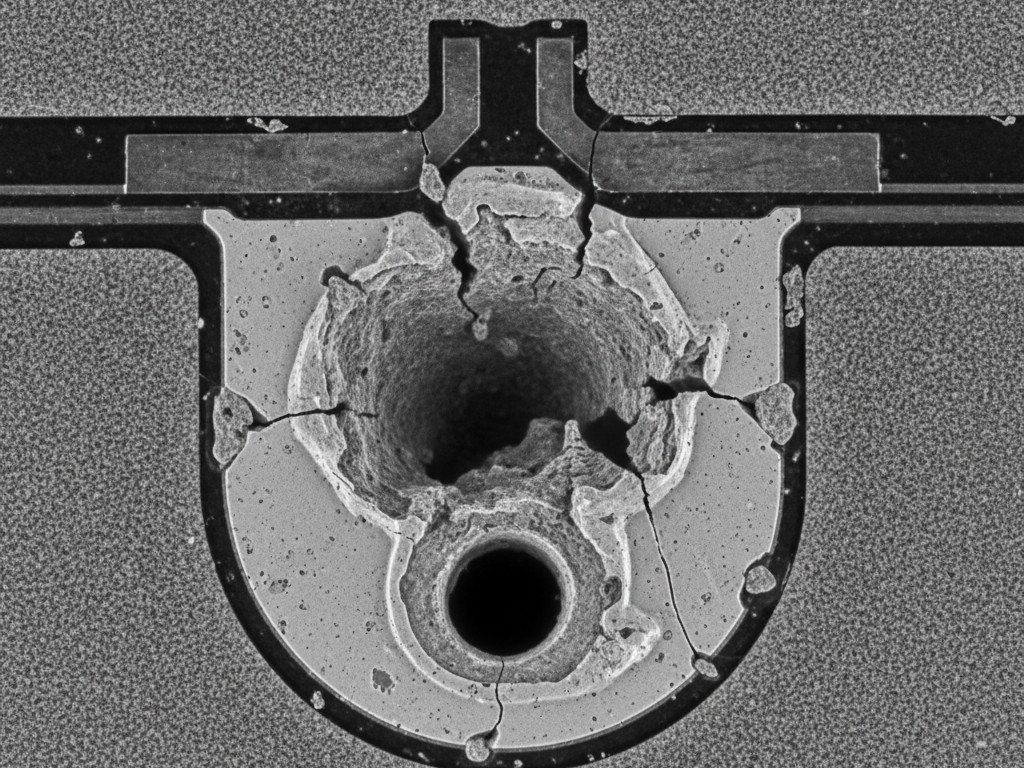
在回流過程中,溫度會超過 SAC305 錫焊的液相線點(約 217°C),最高達到 245°C。在那六十秒的時間裡,任何 trapped 的水分、助焊劑溶劑或空氣都會膨脹。氣體膨脹激烈。如果通孔僅僅被錫膏覆蓋,那層薄薄的聚合物薄膜就會像氣球一樣被拉伸直到破裂。一旦爆炸,就會將上層的熔融錫噴出。結果是焊點出現火山坑、元件抬起,或出現大到能通過 IPC 類別 3 檢測的空洞。這就是火山效應。氣體除了向上之外無處可去,伴隨著你的可靠性一起升空。
狗骨折的死亡
曾經你可以利用‘狗骨’扇出來避免這個問題。你會在 BGA 瓣的短軌上走一條短路,連接到一個空曠的通孔,保持墊片完整、孔洞分離。那個時代已經徹底過去了,尤其是在高性能數位設計中。
當你面對 Xilinx UltraScale+ 或高密度傳感器,且引腳間距只有 0.4mm 時,路由通路的幾何結構根本不存在。一條3 mil寬、間距也是3 mil的標準焊線所需的空間,比晶片廠商提供的空間還要大。你被迫在墊片上鑽孔。有些工程師可能仍抱著1.27mm引腳間距時的習慣,試圖縮小環圈至危險的程度來維持狗骨,但他們對良率的戰鬥已是無望。標準中階晶圓廠的鑽孔偏差最終會讓你吃苦。物理規則和幾何限制決定了通孔必須在墊片內。問題不再是“是否”,而是“如何”填充那個孔。
帳篷與插頭幻想
最常見的錯誤——也是導致最嚴重現場故障的原因——是假設標準焊膏可以封閉通孔。這通常被規範為 IPC-4761 第六類,或稱為“帳篷並覆蓋”。這是一個具有誘惑力的選擇,因為它不會額外花費;CAM 工程師只需將掩模的開口留在通孔上方就行。
但液相感光阻焊(LPI)並非一種結構材料,它只是一層薄薄的油漆。當你在墊片上帳篷包覆通孔時,你會困住桶內的空氣。在升到 245°C 的過程中,空氣會膨脹。掩模變軟,壓力逐漸增加,直到把熔融的錫蓋推裂,形成前述的火山。即使沒有爆炸,氣泡也可能在冷卻的焊料中殘留,形成一個巨大的空洞,起到熱絕緣的作用。你基本上將高功率處理器放在氣墊上,而非銅熱路。帳篷是一個陷阱。
一些設計師試圖巧妙地使用‘ plugged ’通孔。他們認為‘plugged’意味著孔被完全填滿。但在晶圓廠的術語中,‘plugging’ 通常只是往孔裡額外灌一些錫膏,以阻擋光線。它很少會完全填滿桶狀結構。更糟的是,這會形成非平坦的表面。LPI 會硬化並收縮,導致中央形成凹痕或凹陷。
當組裝廠在那些凹陷的墊片上噴塗焊膏時,體積計算就會出錯。焊膏會浸入凹痕中。BGA球本可以期待平坦表面,現在卻得跨越一個空隙。這導致‘頭在枕頭’缺陷,球只在墊片上,並未充分濕潤,形成間歇性連接,通過工廠測試卻在第一次掉落時失效。‘Plug’不是‘Cap’,而凹痕則是等待發生的缺陷。
唯一的出路:七型(VIPPO)
唯一符合回流物理規則的工程方案是 IPC-4761 第七類(VIPPO,通孔通路鍍層)。這不是一步完成的——而是一系列製造作業,旨在將孔重新轉變為平整的銅墊。
該流程在初期鑽孔和鍍層後開始。製造商將專用的環氧樹脂注入通孔桶內。這不是焊料遮罩,而是專用的孔填充材料。一旦固化,該電路板會經過平整化階段——本質上是機械砂磨,將多餘的環氧樹脂磨平,與銅面齊平。最後,電路板再次放入鍍層槽中。在填充且經過砂光的孔上鍍上一層銅作為封頂。
結果形成的焊盤看起來像實心銅,且行為也如同銅一樣。沒有孔讓氣體釋放,也沒有凹陷讓焊料流入。BGA球體坐落在完美平坦且具導電性的表面上。元件的熱量通過銅封頂傳導,進入通孔的鍍層壁,再傳導到內部平面。這形成一個整體銅焊盤,對氣體釋放具有免疫力。
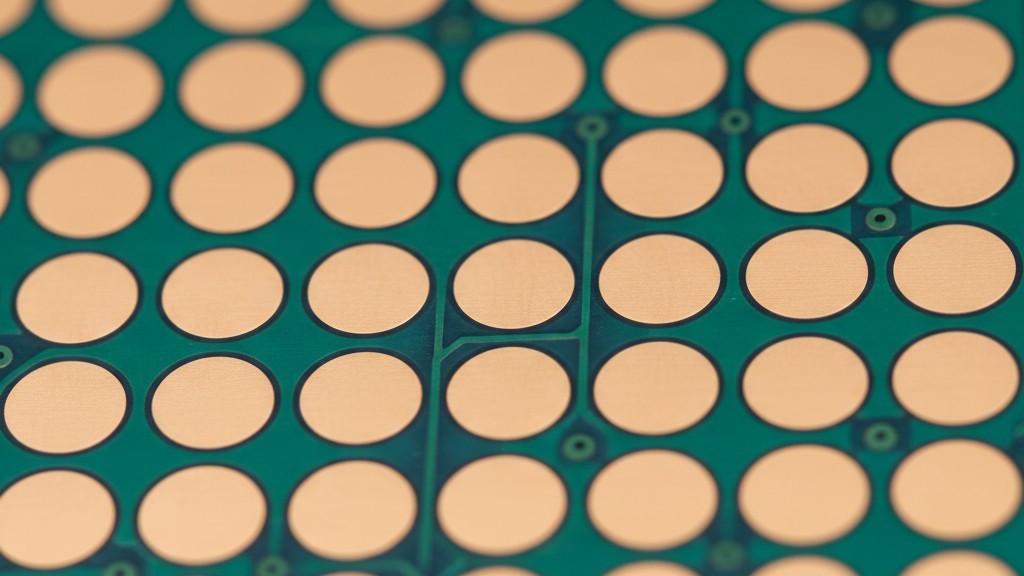
平整化是此流程中不可或缺的一部分。如果你只指定“填充通孔”卻不說明“封頂並鍍層”,你會得到一個充滿環氧樹脂的桶狀通孔,上方暴露樹脂。焊料不會粘附到環氧樹脂上。最終你會得到一個銅圈,中間不易濕潤,這比凹陷更加令人擔憂。你需要封頂層。
導電性神話
當指定填充材料時,會遇到一個持續的爭論:導電與非導電填充。許多工程師直覺認為“導電較佳”,並指定加入銀或銅的環氧樹脂,認為這可以提升熱性能。對於標準可靠性等級,這幾乎總是一個錯誤。
導電膏具有與周圍 FR4 層材顏C値顯著不同的熱膨脹係數(CTE)。在運作中,電路板隨溫升與降溫時,沿 Z 軸擴展的速度與導電填充不同。這個不匹配會產生應力,壓迫銅通孔鍍層。經過多次熱循環後,填充材料像楔子一樣,可能裂開銅膝或將鍍層與孔壁分離。
非導電環氧樹脂專為匹配標準 Tg170 FR4 層材的 CTE 而設計,它能隨電路板一起移動。關於熱傳導:通孔內的熱傳遞主要通過銅鍍層,而非芯材。在許多應用中,銀填充通孔與標準環氧填充的熱阻差異微乎其微,除非你需要傳輸50A的直流電,因為在這種情況下,通孔的電阻是唯一的考量。導電填充的可靠性風險高於理論上的性能提升,建議堅持非導電填充。
撰寫 Fab 記事
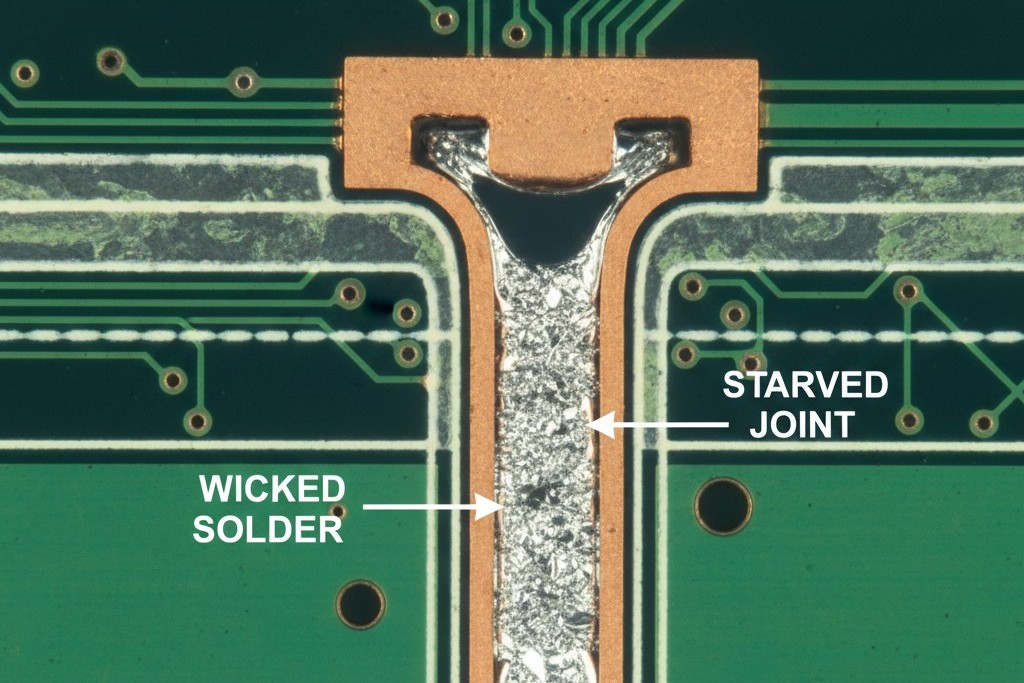
你不能依賴 CAM 工程師猜測你的意圖。如果你只留下通孔在焊盤上的設計並傳送 Gerber 文件,認真負責的工廠會暫停該工作。一些預算有限的工廠則會將其當作開放孔處理,焊料在裝配時會沿著通孔流下,導致元件腳乾燥——這就是典型的“焊料竊賊”。
你必須在製造圖中加入特定層或明確的文字說明。解釋要清楚。不要使用含糊的詞語如“封堵”。請用業界標準定義:
“所有 BGA 焊盤內的通孔(或特定層)需符合 IPC-4761 VII 型。填充非導電環氧樹脂,平整化,並鍍上至少 12μm 的銅封頂。最終表面必須平整且可焊接。”
此流程會增加成本。根據數量和工廠不同,可能會使光板價格增加 15% 至 30%,因為它需要額外的鍍層循環和手動平整步驟。但你付出的不是孔的代價,而是沒有火山的代價。將這個 20% 的板價增幅與製造 5,000 單位後因 QFNs 浮在空氣泡上的失敗成本相比較,數學很簡單。物理規則不能談判。
