當回流爐完成其熱輪廓,板子從蒸氣階段出來,RF屏蔽完好無損地焊接到焊盤時,組裝看起來毫無瑕疵。然而,在功能測試進行三週後,閃現的故障開始浮現。當你拆除屏蔽時,證據一清二楚:散布在板上的微小焊珠、由孔洞擴散的潮濕跡象,以及在最壞情況下,焊橋短路電路。

根本原因?一個看似保守的設計決定,這個原則是從一般PCB設計借來的標準做法,沒有考慮到屏蔽下的獨特環境。那個決定是孔洞封堵(via tenting)。
雖然孔洞封堵在許多情況下是合理的,但在RF屏蔽之下封閉空間會將回流過程轉變為壓力容器實驗。陷阱中的濕氣、焊膏中的揮發物以及環氧樹脂的分解產物都試圖尋找逃逸路徑,當溫度飆升時。由於金屬罩密封在板子上,這些路徑變得稀少。後果表現為出氣損傷、焊球缺陷以及可靠性受損。我們認為,應完全避免在RF屏蔽下及其附近使用孔洞封堵。反對的理由根植於回流的物理學和焊膏在熱應力下的物料行為。
常見做法:隱藏反應焊接炸彈
孔洞封堵,即在孔洞上方施加焊膏的做法,旨在封閉孔洞。這可以防止焊膏在回流過程中從孔中滲出,對許多設計來說是合理的做法。這個做法在IPC標準中被廣泛記錄,並已成為可靠的選擇數十年。在大多數應用中,它可以正常工作,未出現意外。
RF屏蔽打破了這個模型。屏蔽是一個焊接在板子上的金屬結構,用來創建電磁屏障。在回流過程中,這個結構變成半封閉的腔室,將內部與爐子大氣隔離。內部產生的氣體被困住了。這與大多數元件生活在開放式板子上的情況根本不同。
困境由這個封閉空間與板子材料的相互作用而形成。焊膏,一種基於環氧樹脂的聚合物,會吸收空氣中的濕氣。當受熱超過其玻璃轉化點時,這些陷阱中的揮發物會膨脹並尋找釋放途徑。在開放板上,它們會直接排入爐中。在屏蔽之下,它們被困住了。用於封堵的封堵孔,現在變成了弱點。孔洞上的焊膏膜比周圍的更薄,當出氣產生內壓時,這層薄膜可能破裂或起泡。出現的不是蒸氣的乾淨釋放,而是一個局部缺陷,從融化的焊料中爆炸出來。
盾牌下的發生了什麼
無鉛焊料的回流過程通常在250°C左右達到峰值,遠高於大多數焊膏的120-150°C玻璃轉變溫度。當電路板加熱時,膏的環氧樹脂會從玻璃狀、剛性狀態轉變為更有彈性的狀態。這使得吸收的水分能蒸發並移動,形成內部壓力梯度,找到其最弱點:導孔上方的薄膏層。
出氣機制
出氣是指在受熱時,材料內被困的氣體劇烈釋放的過程。在30到90秒的峰值回流期間,覆蓋孔洞的焊膏膜(通常只有15-25微米厚)必須能夠承受這個壓力。如果膜破裂,氣體會迅速逸出,進入焊膏完全融化的環境中。
這股逸出的氣體和環氧分解產物造成湍流,推動微小的焊珠遠離焊盤。這些焊珠散布在屏蔽罩內部,形成潛在缺陷的雷區。
焊球形成的原因以及它們為何重要
焊球是當融化的焊料被排出並孤立固化時形成的微小合金球。由裂開的通孔噴射出的氣流會將這些液滴噴出,這些液滴由於表面張力會自然形成球體。隨著電路板冷卻,它們會在落地的地方固化。
電氣風險是直接的。導電球體可以橋接兩條走線,形成短路。即使不會導致立即失效,鬆動的焊球也是一個可靠性定時炸彈;振動或熱循環可能將其脫離,導致產品壽命中後來短路。對於汽車、醫療或航天等高可靠性應用場景,焊球的存在本身就是拒絕的標準之一。
機械風險較為微妙。被卡在屏蔽罩下的焊球可能會阻礙其緊貼在板子上的位置,降低屏蔽效能。在極端情況下,卡在屏蔽罩和元件之間的焊球可能產生機械應力,導致元件破裂或焊點疲勞。重新加工一塊板以移除屏蔽罩既耗時又昂貴,通常需要完整的再回流流程,並有損板子和屏蔽罩本身的風險。
通過能在回流中存活的處理方式
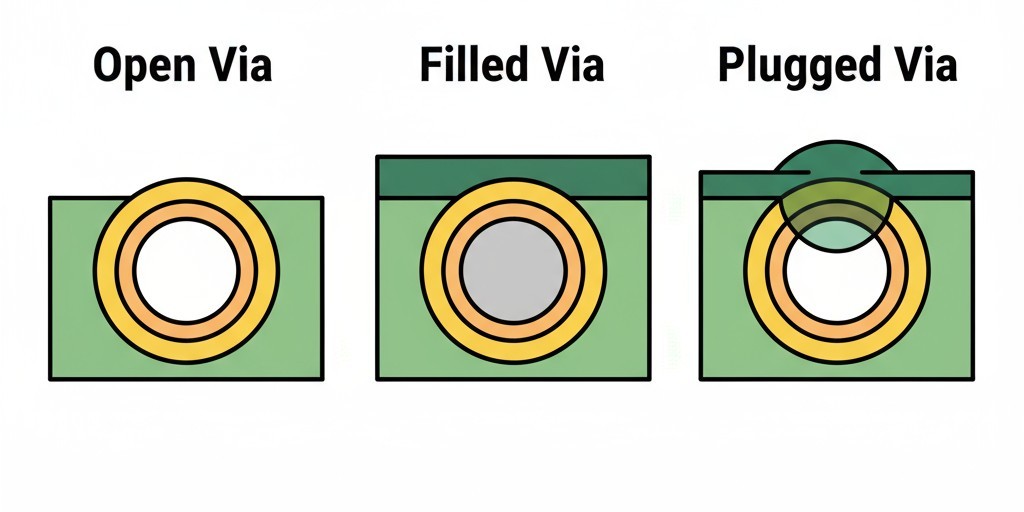
解決方案是刪除通孔上的薄焊料膜,並提供一個受控的排氣路徑。目前,晶振罩下的通孔主要有三個選擇。
開放通孔: 最簡單的選擇是保持通孔開放,並且沒有焊料遮罩覆蓋開口。這為層壓材料中的任何水分或揮發物提供一條明確的排氣路徑,有助於防止壓力積聚。通常情況下,焊料沿通孔桶壁滲入的問題在罩子下很少出現,因為罩子的安裝墊較大,且通常不會靠近細距離元件。這是成本最低、最直接的解決方案。
填充通孔: 這裡,通孔桶壁被填充非導電性環氧樹脂,並經過平整化和鍍層處理。這樣可以消除陷入水分的空隙,有效防止氣體從通孔桶壁逸出。填充通孔的成本顯著較高,通常用於需要在通孔上放置元件的通孔內元件設計(via-in-pad)。雖然效果良好,但對於屏蔽罩下的區域來說,這常常是過度設計。
封閉通孔: 中間折衷方案是,使用焊料遮罩或樹脂塞子填充通孔,並保持在表面以下。這個塞子可以防止焊料滲入,但不能達到密封效果。相比完全填充通孔,這種方式成本較低,但在本特定應用中,並不比開放通孔具有明顯的優勢,因為主要目標是排氣,而不是密封。
一個相關且更具成本效益的方法是 通孔在垂直墊片附近. 通過將開放通孔設置在屏蔽罩安裝墊片外側,並與焊膏沉積保持至少0.2毫米的間隙,可以實現必要的電氣連接,同時避免滲入或填充的成本。
設計以便返工
避免封閉通孔是第一步,下一步則是考慮到屏蔽罩經常需要拆除進行調試、修理或升級的現實情況,合理設計。
屏蔽罩周圍的焊料遮罩開口應該設計成可以進行返工作業的尺寸。常用做法是確定一個開口,擴展0.1至0.15毫米超過屏蔽墊片範圍,這樣可以提供視覺指引,並且確保整個焊點都能夠接觸到。如果開口太小,遮罩會像散熱器一樣,讓返工變得困難;如果太大,則可能暴露附近的走線而造成損害。
假設從一開始就要移除屏蔽罩。在設計安裝墊時,應具有足夠的熱質量和焊料掩模餘裕,以便多次返修而不脫落。這意味著使用比最低連接所需更大的墊片,並記錄正確的返修程序,包括工具的溫度和停留時間。
當屏蔽阻擋訪問時的測試點策略
RF屏蔽罩是一堵牆,阻擋直接探針接觸內部信號。在設計階段,必須將關鍵測試點移到屏蔽罩的外圍。
對於電源和地線網路,這很簡單,因為它們可以在電路板的其他位置接觸。對於敏感的RF或高速信號,常用的解決方案是在屏蔽牆外側設置一個小的交流耦合探針墊。有了這個,可以在不破壞屏蔽完整性的情況下進行測試,雖然還需要考慮到小的寄生電容。
區分通孔縫合與測試通孔。屏蔽罩下密集的小孔陣列用於接地,而非測試。如果需要探測接地連接,應在周邊添置帶有較大直徑的專用測試通孔,並在絲印層明確標示。
修復現有設計
如果你在帶有遮蔽孔的電路板上已遇到逸散氣體問題,選擇有限。最佳方案是進行Gerber層次的修訂,請求生產商移除受影響區域的焊料掩模。如果電路板已經制造出來,可以在組裝前將其在120°C下預烘幾小時,以排除部分水分,減少逸散氣體的嚴重程度。然而,這些工藝調整都不能替代從一開始就正確設計電路板的方法。
