當設計文件進入工程排隊時,我們不會先看佈線或元件放置,我們會先看焊膏層。
大多數設計師將這一層視為銅墊的直接翻譯:如果板上有墊子,模版上應該有完全相同尺寸的孔。這個1:1的邏輯整潔、井然有序,並在CAD環境中數學上完美。它也是現代混合技術板裝配缺陷最常見的原因。
問題在哪裡?Gerber檔案是一個二维地圖,但焊點是三維體積。當我們從屏幕轉到生產現場時,我們將涉及流體動力學、表面張力以及推動金屬膏穿過鋼板的物理限制。
如果我們盲目地根據你的ECAD軟體的“100%覆蓋率”預設輸出來切割模版,我們保證會失敗。在有大型連接器和細間距微芯片的板子上,統一的方法會導致一半的焊膏過多,而另一半又不足。我們並非故意讓你的模版數據變得困難,而是因為物理法則所逼。
焊料是一個體積問題
忘記“覆蓋率”。我們需要以立方密耳(cubic mils)來思考。
焊點的機械完整性——特別是對於電源元件和連接器——完全取決於形成的金屬鉸角的體積。標準的表面貼裝墊子在5mil厚的焊膏沉積下可能看起來沒問題,但穿孔重工插針或USB-C連接器則完全不同。
設計師經常在原型測試期間當連接器脫落時驚慌,認為是部件本身有缺陷或外殼太脆弱。事實上,問題幾乎總是模版厚度。在使用標準4mil或5mil箔的信號板上,USB-C連接器的支腳需要被深深插入PCB的柱狀內。若我們使用普通的箔片,我們只會提供填充該柱狀空間所需焊膏的一部分。焊膏在表面印刷,重熔,然後融入孔中,留下脆弱、缺乏焊料的弧面,在首次插入時容易破裂。
為了修正這個問題,我們必須計算孔的總體積(扣除引腳),加上一個10%的緩衝空間用於焊劑燃燒,反向工程設計模版孔口,精確送達該體積的焊膏。通常,板上墊子大小不足以容納如此多的濕焊膏,這迫使我們進行過度印刷——故意在阻焊層上印刷焊膏,使其在重熔時回拉到墊子上。
面積比樓層
當大部件缺乏焊膏時,小部件卻有相反問題:它們拒絕放手。這就是“面積比”規則成為生產的硬性底線的原因。
模板印刷是在兩股力量之間的較量:黏附在PCB焊垫上的膏體表面張力,以及黏附在模板孔壁內側的摩擦力。為了成功釋放膏體,焊垫面積必須比孔壁的面積大得多。
行業標準(IPC-7525)將危險區的比例設為0.66。如果比例低於這個值(例如,0.4mm間距的BGA或01005容量器),膏體會在模板內堵塞,而不是在電路板上沉積。你可能只有一次良好的印刷,也許兩次,然後孔口就會堵塞。自動光學檢查(AOI)機會立即標記“焊料不足”。
我們可以嘗試用使鋼材疏水的納米塗層來稍作欺騙,有效地在孔壁上做潤滑,但這只是暫時的解決方案。這些塗層在經過10,000個循環或激烈的底部清洗後會磨損。唯一永久的工程修正方法是改變幾何形狀:我們要么讓孔口更大(風險橋接),要么讓模板箔更薄以減少壁面積。
大部件 / 小部件衝突

現在我們遇到了現代電子裝配的核心矛盾:’大件/小件’問題。你可能有一個重型的D2PAK電壓調節器,需要大量焊料散熱,旁邊則是需要微量膏料避免短路的0.35mm間距晶圓級封裝。
如果我們使用一個“標準”的5mil模板箔——我們在見到的90%報價請求中的默認選擇——就會犧牲一個這些元件。5mil箔提供足夠的體積給D2PAK,但對於微小晶片來說太厚;比例整比會不正確,膏料也不會釋放。如果改用3mil箔以適應微小晶片,D2PAK就會出現空洞和熱故障。
設計師經常會問:“為什麼不能就這樣縮小小件的孔口尺寸?”我們可以這樣做,但要記得面積比:在保持箔厚不變的情況下縮小孔口面積只會使比例變得更差。你無法用X-Y軸調整來解決Z軸問題。
工程地形學:階梯模板
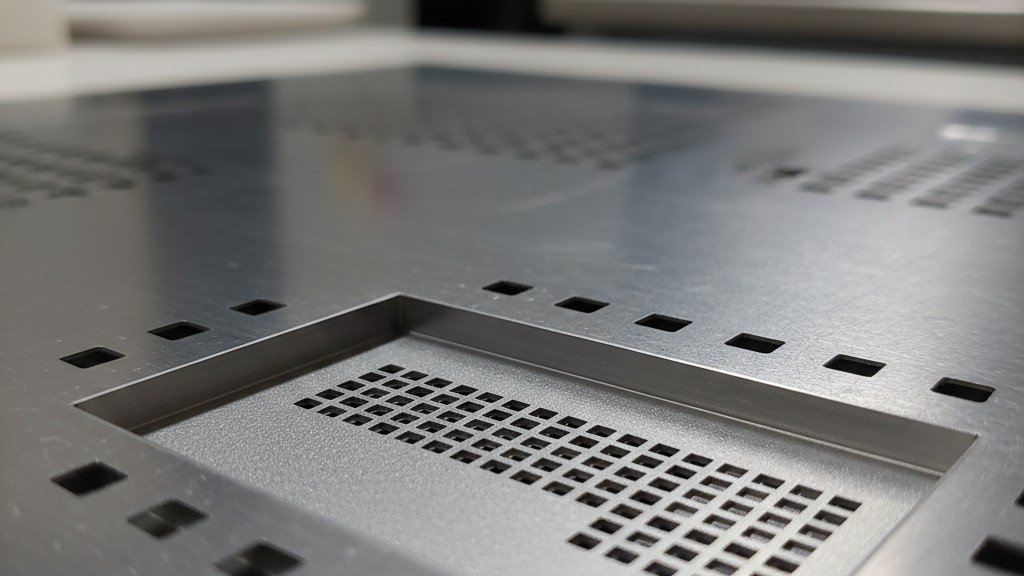
我們必須將模板視為一張類似地形圖的設計,而非僅僅是一張平坦的紙。
我們使用步進模板來創造局部厚度區域。對於D2PAK或USB連接器,我們可能會“階梯式升高”模板,在特定區域焊接較厚的鋼片(比如6mil或8mil)。對於細間距BGA,我們則會刻蝕一個“階梯式減少”口袋,將厚度降低到3.5mil或3mil,只用於該元件的封裝區域。
這不是魔法;它需要仔細的佈局。刮刀刃很有彈性,但不是流體。它需要過渡空間——通常是50到100 mil,以便在升起或降低階梯時不跳過或刮出孔內的膏料。我們必須仔細規劃這些禁止區,確保沒有重要元件放在階梯的斜坡上。然而,當操作正確時,它可以讓我們在一次過程中為大功率元件打印大量膏料,並進行高精度微元件的微型沉積。這將被認為“無法製作”的電路板轉變為達到99%良率的產品。
窗格與脫出氣體
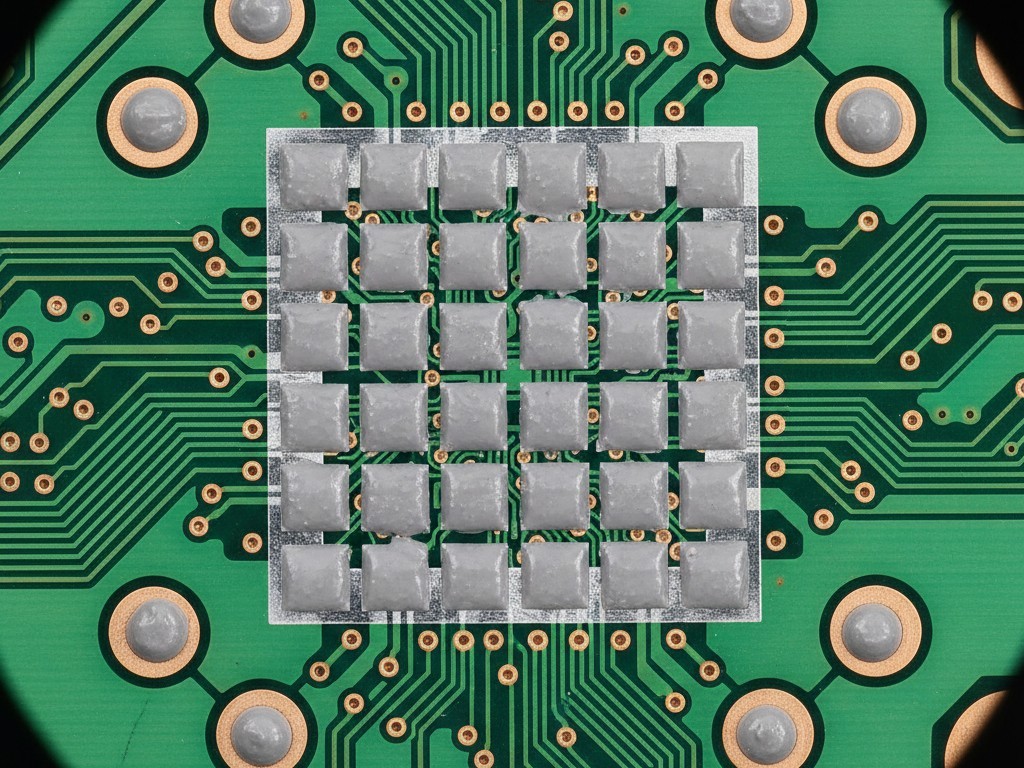
幾何修改不限於厚度。我們還必須對抗通鋅的行為。
在像QFN或功率FET這樣的大熱墊下,設計師通常會畫出與銅墊相匹配的實心膏膜模版。如果我們印刷該圖案,在回流時會在晶片下方捕捉大量揮發物(助焊劑溶劑)。當助焊劑沸騰時,氣體無處可逃,從而產生大量空洞——焊點內的氣泡阻礙熱傳導。
為了防止這種情況,我們在Gerber中忽略了實心塊,並採用“窗格”縮減。我們將大型方形孔口分割成一個個較小的正方形格子,並用10-15密爾的鋼製通道分隔。這些通道充當排出濃氣的高速公路。這對尋求最大熱傳導的電力工程師來說聽起來似乎有悖常理,但實際上卻是有效的。 較少 粘貼(常常是60-70%的覆蓋範圍,而不是100%)實際上會導致 更多 金屬與金屬接觸,因為它消除了空隙。
修改的經濟性
成本往往受到阻力。一個標準激光切割模版可能花費$150到$200。帶有納米塗層的多層階梯模版可能花費$350到$450。採購團隊看著那一行項目,並問我們是否能用標準選項‘讓它運作’。
將其與替代方案的成本進行比較。
重新加工一個橋接的0.4mm BGA不僅困難,通常在不損壞電路板或鄰近元件的情況下幾乎不可能。更換已斷裂的連接器的成本是原始零件的五十倍。一個合適模版的非經常性工程(NRE)費用是一筆一次性費用。因為我們試圖違反物理法則而刮掉一千塊電路板上的焊料的成本是反覆的、令人痛苦的,也是完全可以避免的。我們修改數據,因為一開始就做對的成本永遠比事後修正的成本低。
