銅竊取應該有效。這個策略是常見且合理的:在電路板的稀疏區域添加銅填充,平衡整體密度,並降低製造過程中的應力。對於許多設計來說,這完全有效。但當過於激烈地應用,且未考慮熱行為時,竊取就不再是解決方案。它反而成為原本旨在解決問題的根源。應該平坦的板子從回流爐中出來時變形,元件錯位,並且焊點受損。

這個失敗是反直覺的,因為翹曲的根本原因不是抽象的銅不平衡,而是在回流循環中熱不均勻加熱。添加銅改變了板子的熱質量和熱分佈。若在不了解其對峰值回流溫度下加熱對稱性的影響時就放置銅,就會造成新的熱不平衡——常常比原本更糟。不同區域以不同速度加熱,並保持不同的時間,推動差異性膨脹,主體無法吸收這種變形而不變形。
答案不是放棄銅平衡。而是認識到堆疊對稱、受控局部銅密度和適當的面板支撐遠比一刀切的竊取更有效。這些方法直接解決熱不對稱問題,而不是將銅分佈僅視為幾何練習。要理解何時竊取會使情況更糟,你首先要理解影響一塊板子在250°C時的熱力學原理。
回流翹曲的熱力學
翹曲根本上是受制約的差異性膨脹問題。印刷電路板是由具有不同熱膨脹係數(CTE)、熱質量和熱導率的材料構成的複合材料。當這種複合材料快速且不均勻地加熱時,內部應力會累積。如果這些應力超過基板在高溫下的彈性極限,電路板就會變形。變形可能是暫時的,隨著冷卻而放鬆,或者在基板屈服或冷卻過程中鎖定應變後變成永久變形。
為什麼差動膨脹會產生扭轉
材料的熱膨脹係數描述其在溫度每升高一度時尺寸變化的程度。銅的CTE約為17 ppm/°C。FR-4層壓板,最常見的PCB基底,其面內CTE約為14-17 ppm/°C,但其通厚CTE則高得多,通常為60-70 ppm/°C。這種不匹配意味著隨著溫度升高,銅和FR-4想以不同的速率膨脹。
它們被黏合在層壓板中,無法自由膨脹。銅限制FR-4,而FR-4限制銅,產生內部應力。如果板子均勻加熱,並且銅在堆疊中對稱分佈,這些應力是可控的。電路板均勻擴展,堆疊對稱保持中性軸居中,並且上下的平衡力使電路板保持平整。
然而,均勻加熱是一種奢侈。當板子的一個區域比另一個區域更熱時,它會想要擴展得更多。被束縛在較涼的區域,它無法這樣做,應力在邊界處累積。如果熱梯度嚴重且持續定向——比如一側總是比另一側更熱——電路板就會彎曲或扭轉來紓解應力,尋求一個能最小化內部應變能的新的平衡形狀。
時機非常重要。當FR-4接近或超過其玻璃轉移溫度(通常為170-180°C)時,其韌性顯著增加。在回流峰值中,當溫度達到或超過240°C,基底處於最低韌性狀態。這是其最大脆弱的時刻。這時的熱不平衡會導致電路板變形。如果這個變形超過軟化樹脂的屈服點,冷卻後電路板將無法完全恢復其形狀。
銅:熱質量與熱傳遞
在回流過程中,銅扮演著兩個角色:它既是熱質量,也是熱傳導通道。這兩者都是其物理性質的結果——高比熱和比 FR-4 超高的熱導率。
作為熱質量,銅決定了提高其溫度所需的能量。具有大量銅平面的板子需要更多的能量和時間來達到回流溫度,而具有稀疏線路的板子則較少。這意味着高銅密度區域的加熱速度較低銅密度區域慢。如果一個板子左半部有大型實心銅平面,而右半部只有輕量佈線,則在升溫過程中左半部的溫度會滯後。在任何時刻,右半部較熱,形成驅動翹曲的熱不對稱性。
作為熱傳導通道,銅的高熱導率(約400 W/m·K,相較於 FR-4 的0.3 W/m·K)使其能迅速重新分配熱量。大型銅平面不僅因質量而緩慢升溫,它還能將熱量從局部熱點傳播開,均勻其表面溫度。雖然這是有益的,但也意味著有銅或無銅的區域在根本上形成不同的熱區。一個實心銅區域具有緩慢而均勻的熱響應,而只有線路的區域則反應較快且具有局部性。

銅不僅增加了質量;它還從根本上重構了電路板的熱景觀。這也是為什麼必須將其分佈視為熱設計的問題,而非僅僅是製造上的均勻性。
銅分佈如何控制加熱的對稱性
熱對稱意味着電路板的所有區域在大致相同的時間達到相同的溫度。雖然完全對稱是不可能的,但目標是在峰值回焊階段將熱梯度最小化,此時電路板最為柔韌。
銅分佈決定了這個對稱性,通過定義板子的熱質量和熱導率圖。具有均勻銅密度的板子具有相對均勻的熱響應,整體吸收熱量。具有高度不均勻銅的板子則成為具有不同熱時間常數的區域拼貼——密集區域滯後,而稀疏區域領先。
多層板的問題更加複雜。考慮一個六層設計,其中電源平面僅覆蓋一半的板面。那一半的板子具有顯著更高的熱質量。在回流過程中,它較慢升溫,形成從稀疏一側到密集一側的持續梯度。如果這個梯度沿著板子的長度,則會產生弓形。如果具有旋轉不對稱,就會扭曲。
回流曲線可以進一步放大這個問題。曲線的浸泡階段旨在在最後的升溫到峰值前平衡溫度,但它並非無限長。如果板子具有明顯的熱質量不平衡,浸泡時間可能不夠。當爐子升溫至 240-250°C 時,低質量區域會先過度升溫,而高質量區域仍在追趕。這是翹曲開始的關鍵時刻。
一旦形成明顯的熱區,它們就會相互作用。密集區域中的大型銅平面會將熱量拉入自身,讓該區域保持較冷較長時間,並加劇與相鄰稀疏區域的梯度。缺乏銅的熱緩衝,這些稀疏區域會快速加熱。這個梯度會持續到峰值時,導致板子翹曲。
蓋布竊取陷阱
應用銅偷取的本能根植於如均勻蝕刻和鍍層等有效製造問題的疑慮。但當用作達到目標百分比的整體填充時,偷取往往會產生它本意要防止的熱不對稱性。
這就成了一個問題。
當加入銅時,會產生新的不平衡
盜取會增加添加地區的熱質量。在一個具有集中銅的功能區域和稀疏走線的板子上,盜取通常只在稀疏區域添加。這些區域之前熱質量較低、加熱迅速,但現在加熱速度變慢了。
這並不移除重功能銅;它只是改變了熱平衡。如果偷取過於激烈,可能會將平衡推得過遠。先前稀疏的區域現在可能具有與功能區域相當的熱質量,但具有不同的幾何形狀,造成一個新的、難以預測的不平衡。
問題不僅在於密度,而在於位置和意圖。如果在回流期間已經較冷的區域進行偷取,在那裡增加熱質量會使其更冷,進一步加劇梯度。 blanket偷取策略並未作出區分;它們是根據密度目標進行填充,而非熱分析。結果常常是更多的銅出現在不該有的地方。
當偷取直接添加到內層平面之上的外層,並且該表面質量吸收爐內的熱並向內傳導時,就會出現特定的失效模式。如果內層已經具有高熱質量,外層的偷取會增加該堆叠的總質量,但不改善熱滲透到核心的效果。核心進一步滯後,表面到核心的梯度加大,並且厚度方向的應力積累,推動面內翹曲,因為表面層的膨脹比核心更大。
在峰值溫度下的偷取
回流峰值是最大熱應力和最小基板剛性的時刻。在這裡存在的任何熱失衡都將產生最大的影響,因為電路板的抗變形能力處於最低點。偷鎖定在一個熱結構中。如果該結構在峰值溫度時出現失衡,電路板每次經過烤箱時都會如此。
烤箱無法解決由電路板結構內在造成的失衡。如果烤箱提高熱量,使較冷的高質量區域達到溫度,熱響應區域將超越。電路板在不同區域達到不同的峰值溫度。較熱的區域膨脹更多,較冷的區域膨脹較少。電路板變軟。它扭曲。隨著冷卻,變形可能變成永久的,導致元件位置偏移和焊點受損——這是標準電測試無法察覺的故障。
堆疊對稱性:主要的翹曲控制方法
控制翹曲最有效的方法是設計一個熱學和機械對稱於其中央平面的電路板堆疊。這確保了在電路板上半部分的熱膨脹力由底部相等且相反的力進行反映。沒有淨彎曲力矩,電路板就能保持平坦。
平衡銅層,層疊面到層疊面
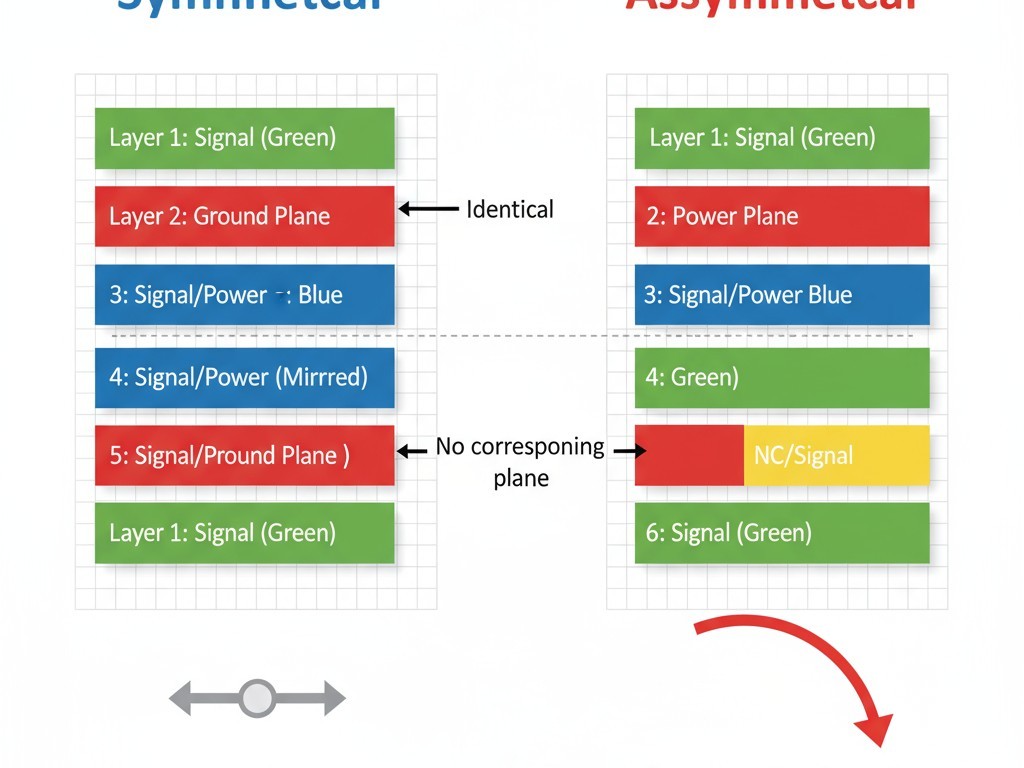
堆疊對稱意味著在一層銅特徵的每一側,另一層也有相應的特徵,並且兩層距離電路板中心約等距。在六層堆疊中,第2層應該鏡像第5層,第3層應該鏡像第4層。如果第2層是實心接地層,第5層也應是面積和厚度相同的實心接地層。這種鏡像平衡通過電路板的厚度來平衡熱質量,確保上下半部分以相同速度加熱。來自CTE不匹配的應力仍然存在,但它是對稱的,因此電路板可以均勻膨脹而不會彎曲。
外層(第1層和第6層)也應該平衡。雖然由於元件佈局,實現完全相同的銅層往往不可能,但目標是使整體銅量和分佈盡可能接近。材料選擇也很重要;核心層和預浸料厚度應在中心對稱,以對齊機械和熱中立軸,最大限度地提高電路板的抗翹曲能力。
當堆疊修改受到限制時
完美對稱並不總是可能的。成本可能限制層數,或設計需要不能鏡像的平面。需要在第2層具有較大接地平面而第5層沒有相應平面的電路板本身就是不對稱的。
在這些情況下,一種方法是在鏡像層使用非功能性的部分平面。用陰影或網格銅層覆蓋相同區域,增加熱質量並改善對稱性,而不形成實心電氣平面。這種折衷通常可以將翹曲控制在可接受的範圍內。折衷方案是增加銅的用量用於非功能性特徵,這是一個與翹曲產量影響權衡的成本。
當堆疊對稱性被破壞時,電路板更容易翹曲,容錯空間也更小。在已經不對稱的堆疊中加入激進的偷鎖,尤其危險,因為它可能與現有的不平衡狀況產生不可預測的相互作用。
無需激烈填充的受控銅密度
如果堆疊對稱是主要的防禦手段,受控的銅密度是管理局部不平衡的策略工具。目標是在必要的地方、以所需的量添加銅,而不引發新的熱問題。這需要由全局轉向局部平衡,並配合回焊過程中的機械支撐。
局部平衡勝於全球填充
局部平衡是指解決特定區域的銅密度,而非在所有位置都採用均勻的填充圖案。該過程從辨識銅集中和稀疏的區域開始,然後利用熱直覺判斷在何處添加銅會有幫助與否。
如果一個極低密度的區域被中等密度的區域包圍,輕微的偷竊可以緩和熱不連續性。目標並非達到全球密度的目標,而是降低梯度。如果周圍區域具有30%的銅,而稀疏區域只有5%,將其提升至15%可能已經足夠。若用激進的偷竊將其推升至30%,可能會超出目標。
這也意味著避免在不需要的地方進行偷竊。僅為了符合任意的全局密度目標而向熱穩定區域添加銅,會增加不必要的熱質量並改變平衡。這是忽略分佈的僵硬設計規則的陷阱。填充的幾何形狀也很重要。帶有破折或點陣圖案的填充產生的有效熱質量比實心填充低,並允許更細的控制。它們可以滿足製造的最低要求,而不會主導區域的熱行為。
實用方法:僅在滿足製造商最低要求的情況下,使用粗糙、低密度的填充。每次增加銅的合理性都應基於區域來判斷,而不是作為一個全局操作。
面板支援與工具支援
面板支援是一種與熱設計相輔相成的機械策略。即使電路板存在熱不平衡,只要在回流焊爐中充分支撐,亦可保持其平整。支撐限制了電路板在通過最脆弱的高溫狀態時的變形能力。
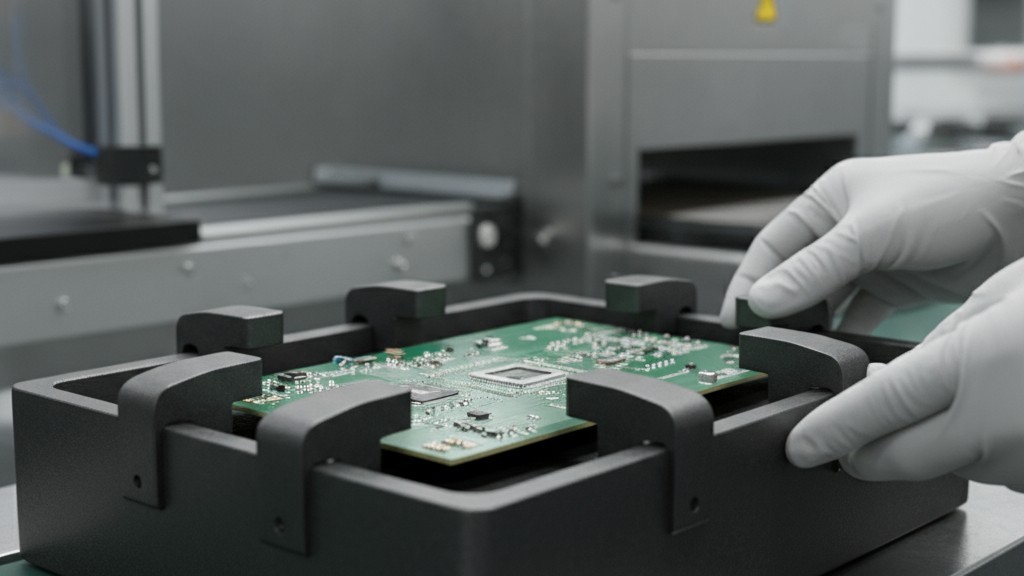
仍附著在面板上的電路板由面板導軌限制,導軌較為剛硬,能保持整個組件的平整。因此,許多高可靠性組件都以面板形式進行回流。對於單個電路板,回流載體或固定裝置提供相同的功能。這些堅固的框架,常由低CTE材料如石墨複合材料製成,通過機械力量使電路板保持平整。折衷的代價是載體的自身熱質量,可能影響回流曲線。
支援並不能根除熱不平衡,它只能抑制由此產生的翹曲。電路板仍存在內部應力,可能影響焊點。因此,支援是一種緩解策略,而非萬靈藥。最佳效果來自通過設計最小化熱不平衡,並利用機械支援管理殘餘風險。
何時使用竊取策略才是合理的決定
銅偷竊本身並非壞事。當盲目應用,作為適當堆疊設計和密度控制的替代方法時,就會變成問題。使用它的決定應該是經過深思熟慮的。
何時才是合理的?
- 為了符合製造最低要求。 許多製造商要求在均勻鍍層中銅密度最低值(例如20-30%)。如果設計低於此標準,則必須進行一定程度的填充。在這種情況下,只添加足夠達到最低要求的銅,並使用低密度圖案。這是一個製造限制,而非熱優化。
- 當熱模擬顯示明顯的好處時。 在某些情況下,建模可能顯示在特定熱點上添加銅能使其熱質量剛好增加到與相鄰區域平衡的程度。這是正確的、具有外科手術性質的熱工具偷竊操作,與大範圍填充相反。
- 當電路板本身具有剛性時。 厚、小或高度對稱的電路板可能可以容忍激進的偷竊而不會出現問題。決策基於風險。如果電路板邊緣脆弱——薄、大或不對稱——則必須嚴格控制偷竊。
指導原則是節約。僅在明確需要並且清楚知道不會引發更嚴重問題的情況下添加銅。優先採用最小化、局部化的偷竊。首先依賴堆疊對稱來達到熱平衡,並使用面板支撐來管理剩餘風險。將偷竊視為針對性的修正,而非標準的完成步驟。您的電板在回流時將保持平整,您的組裝良率也將反映出這種設計紀律。
