Keheningan prototipe yang mati sangat berat. Ini bukan cuma tentang tidak adanya suara kipas atau LED gelap di antarmuka debug. Ini adalah perhitungan biaya yang langsung, tenggelam. Ketika sebuah papan prototipe gagal inisialisasi—mungkin BGA tidak duduk dengan benar saat perakitan, atau cacat desain membutuhkan penggantian—fokus segera beralih ke kotak hitam besar di tengah PCB tersebut.

Di sektor dengan keandalan tinggi, kotak itu sering berupa FPGA kelas atas, seperti Xilinx Kintex UltraScale atau Intel Stratix 10. Ini bukan komponen komoditas; mereka adalah aset. Dalam masa terbatasnya rantai pasokan, mengganti chip tunggal itu bisa memakan waktu 52 minggu atau markup pasar broker yang melanggar anggaran proyek. Papan itu sendiri, tumpukan 12 lapis dengan via buta dan tertanam, mungkin memakan biaya fabrikasi dan perakitan sebesar $5.000. Perbaikan ulang bukanlah perbaikan standar. Ini adalah operasi penyelamatan di mana seluruh garis waktu pengembangan dipertaruhkan.
Fisika Tidak Bernegosiasi
Miskonsepsi yang berbahaya tetap ada bahwa melepas Ball Grid Array (BGA) hanyalah soal mengaplikasikan panas sampai solder meleleh. Sikap ini menghancurkan prototipe. Alat pemanas genggam, meskipun bagus untuk menyusutkan tabung, adalah alat penghancur untuk interkoneksi berdensitas tinggi.
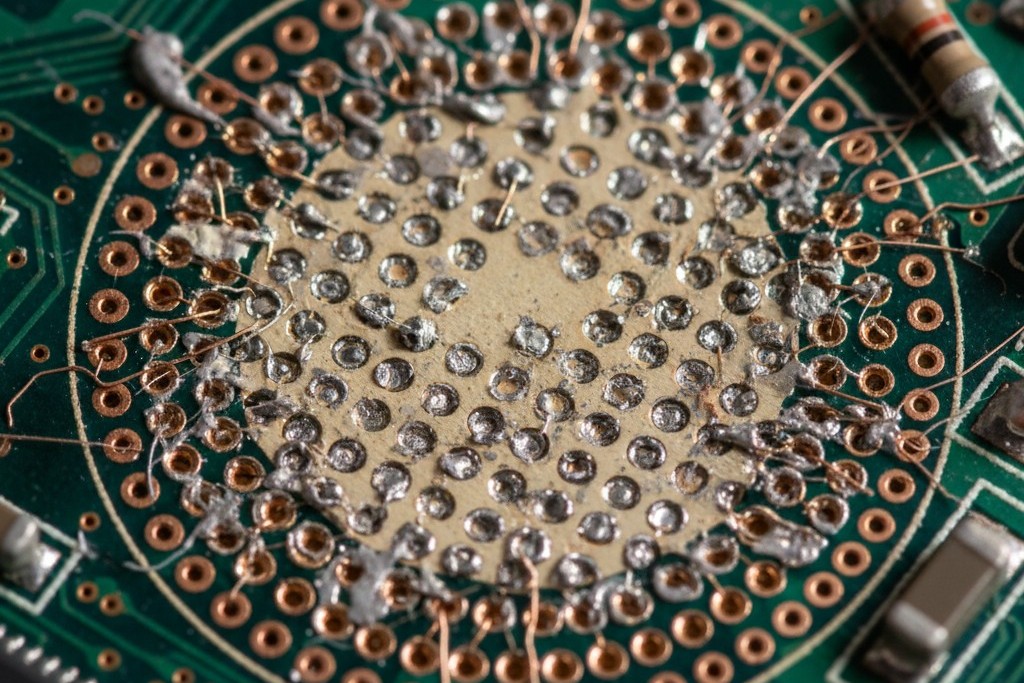
Fisika ini bergantung pada massa termal dan koefisien ekspansi termal (CTE). FPGA modern duduk di atas papan yang penuh dengan ground plane tembaga yang dirancang khusus untuk meny dissipasi panas. Jika Anda menembakkan udara panas ke bagian atas chip tanpa memanaskan bagian bawah papan secara cukup, Anda menciptakan gradien termal vertikal. Bagian atas mengembang sementara bagian bawah tetap dingin dan kaku. Akibatnya adalah deformasi. Ketika papan melengkung, itu menarik terhadap sambungan solder. Jika sumber panas tidak terkendali, Anda berisiko mengalami “pad cratering”—secara harfiah menarik pad tembaga dari laminasi fiberglass. Begitu pad robek dari jejak internal, papan dianggap sebagai limbah. Tidak ada jumper wire yang dapat secara andal memperbaiki pasangan diferensial kecepatan tinggi yang berjalan di 10 Gbps.
Ini sebabnya insinyur harus mengadopsi pola pikir “pembuatan lokal”. Tujuannya adalah mereplikasi profil reflow asli—kurva suhu spesifik selama waktu—yang dialami papan di oven manufaktur. Seluruh perakitan harus mencapai suhu rendaman (biasanya sekitar 150°C hingga 170°C) untuk mengaktifkan flux dan menyamakan suhu di seluruh PCB. Barulah kemudian Anda menerapkan energi lokal ke komponen itu sendiri untuk mendorongnya melewati titik cair dari 217°C. Fisika mengabaikan tenggat waktu; jika ramp suhu terlalu curam, uap yang terperangkap di dalam kemasan chip mengembang menjadi uap, menyebabkan kemasan melaminasi lagi atau “popcorn”. Chip yang meletus adalah chip mati.
Proses: Intervensi Terkontrol
Menghemat komponen sebesar $2.000 menuntut ketelitian. Proses dimulai beberapa hari sebelum perbaikan aktual dengan manajemen kelembapan. Kecuali papan disimpan dalam kotak kering dengan indikator kelembapan yang membaca tingkat aman, papan harus dipanggang. Protokol IPC-1601 standar mengharuskan memanggang kelembapan dari PCB dan komponen untuk mencegah delaminasi akibat tekanan uap tersebut. Mengabaikan langkah ini adalah penyebab paling umum dari kegagalan yang tidak terlihat yang muncul berminggu-minggu kemudian.
Setelah papan kering, papan dipindahkan ke sistem perbaikan khusus—biasanya mesin dengan optik split-vision, preheater inframerah bagian bawah, dan nosel konveksi atas kendali komputer. Automasi menggerakkan proses ini, bukan sentuhan manual. Termokouple sering dipasang di papan pengorbanan untuk memetakan profil thermal secara tepat. Kita perlu mengetahui bahwa saat mesin menunjukkan 230°C, bola solder di bawah pusat grid 35x35mm benar-benar mencapai reflow, bukan duduk dingin karena pendingin panas terdekat.
Penghapusan itu sendiri terasa tidak mewah jika profilnya benar. Nosel vakum turun, solder mencair, dan komponen terangkat secara vertikal tanpa kekuatan apa pun. Kekhawatiran memuncak segera setelahnya: perawatan lokasi. Ini melibatkan pengangkatan manual solder lama dari pad PCB menggunakan soldering iron dan wick braid. Di sinilah tangan teknisi sangat berperan. Obeng harus “mengapung” di atas pad; tekanan ke bawah apa pun berisiko mengangkat pad, yang biasanya fatal bagi papan. Meskipun metode perbaikan epoxy ada untuk pad yang terangkat, ketidaksesuaian impedansi yang diperkenalkan oleh perbaikan sering kali tidak dapat diterima untuk jalur FPGA berfrekuensi tinggi. Pad harus bersih, datar, dan berkilau tembaga sebelum chip baru atau yang sudah di-reball dapat ditempatkan.
Persamaan Reballing

Terkadang tujuan bukanlah sebuah chip baru, tetapi menyelamatkan chip lama dari papan mati agar bisa digunakan di tempat lain, atau memasang kembali chip yang mengalami kegagalan koneksi. Ini memperkenalkan sub-disiplin reballing. Sebuah BGA yang dilepas memiliki tonjolan timah solder yang berantakan dan tidak teratur di bagian bawahnya. Tonjolan ini harus dibersihkan dan bola solder baru dipasang.
Ini adalah perhitungan ROI murni. Reballing pada mikrokontroler komoditas $5 adalah omong kosong secara finansial; jam kerja melebihi biaya komponen. Tapi untuk Virtex UltraScale+ seharga $15.000, reballing wajib dilakukan. Proses ini melibatkan stensil khusus yang cocok dengan jejak chip, flux lengket, dan ribuan bola solder yang sudah dibentuk sebelumnya (sering berdiameter 0,4mm atau 0,5mm) yang diaplikasikan dan disusun secara manual.
Ketidakpastian tak terhindarkan, meskipun. Setiap kali sebuah die silikon menjalani siklus reflow—dipanaskan hingga 240°C dan didinginkan—stres termal akan terkumpul. Ketidaksesuaian ekspansi termal antara die silikon, substrat paket, dan PCB memberi tekanan pada interkoneksi internal. Walaupun sebuah chip biasanya bisa bertahan dua atau tiga siklus reflow (perakitan awal, pelepasan, reballing, penempatan), hasilnya tidak pernah dijamin. Kita dapat mengurangi risiko dengan profil yang sempurna, tetapi batas kelelahan bahan tidak dapat diubah.
Keputusan untuk melakukan perbaikan biasanya bergantung pada rasio "penggantian vs. pemulihan". Jika silikon tidak dapat diganti karena kekurangan, atau jika papan mewakili minggu-minggu waktu pembuatan yang unik, investasi dalam profil termal yang tepat dan waktu operator yang terampil akan sangat kecil dibandingkan biaya memulai dari awal. Peralatan—pemanas pra, sistem visi, kepala reflow inert nitrogen—berfungsi untuk mengubah bencana menjadi penundaan rekayasa standar.
