Kupferdiebstahl sollte funktionieren. Die Strategie ist üblich und die Logik ist schlüssig: Kupferfüllung in spärlichen Bereichen einer Leiterplatte hinzufügen, die Gesamtdichte ausgleichen und Stress während der Fertigung reduzieren. Für viele Designs funktioniert das perfekt. Aber bei aggressiver Anwendung, ohne Rücksicht auf thermisches Verhalten, hört der Diebstahl auf, eine Lösung zu sein. Er wird zur Ursache des Problems, das er eigentlich lösen sollte. Platinen, die flach aus dem Reflow-Ofen hätten kommen sollen, kommen verdreht heraus, ihre Komponenten sind verschoben und Lötstellen beschädigt.

Dieser Fehler ist kontraintuitiv, denn die Ursache für Warpage ist nicht das abstrakte Kupferungleichgewicht, sondern asymmetrisches Erhitzen während des Reflow-Zyklus. Das Hinzufügen von Kupfer verändert die thermische Masse und Wärmeverteilung einer Platine. Wenn dieses Kupfer ohne Verständnis darüber platziert wird, wie es die Heizsymmetrie bei den Spitzenreflow-Temperaturen beeinflusst, schafft es neue thermische Ungleichgewichte—oft schlimmer als die ursprünglichen. Die Platine verdreht sich, weil verschiedene Bereiche unterschiedlich schnell erhitzen und die Hitze unterschiedlich lange halten, was differentielle Ausdehnungen verursacht, die das Substrat ohne Verformung nicht aufnehmen kann.
Die Lösung besteht nicht darin, den Kupferausgleich aufzugeben. Es ist vielmehr wichtig zu erkennen, dass Stackup-Symmetrie, kontrollierte lokale Kupferdichte und richtige Panel-Unterstützung weitaus effektivere Strategien sind als blanket Diebstahl. Diese Ansätze adressieren die thermische Asymmetrie direkt, anstatt die Kupferverteilung nur als geometrische Übung zu betrachten. Um zu verstehen, wann Diebstahl die Dinge verschlimmert, muss man zuerst die thermischen Mechaniken verstehen, die eine Platine bei 250°C steuern.
Die Thermische Mechanik von Reflow-Verformung
Warpage ist grundsätzlich ein Problem des eingeschränkten differentiellen Ausdehnens. Eine Leiterplatte ist ein Verbundmaterial aus Stoffen mit unterschiedlichen thermischen Ausdehnungskoeffizienten (CTE), thermischer Masse und Wärmeleitfähigkeit. Wenn dieses Verbundmaterial schnell und ungleichmäßig erhitzt wird, bauen sich innere Spannungen auf. Überschreiten diese Spannungen die elastische Grenze des Substrats bei hohen Temperaturen, verformt sich die Platine. Die Verformung kann vorübergehend sein und sich beim Abkühlen entspannen oder dauerhaft werden, wenn das Substrat nachgibt oder der Abkühlungsprozess die Spannung festsetzt.
Warum differentielle Ausdehnung Drehung verursacht
Der CTE eines Materials beschreibt, um wie viel sich seine Maße mit jedem Grad Temperaturanstieg verändern. Kupfer hat einen CTE von etwa 17 ppm/°C. Das FR-4-Substrat, das am häufigsten verwendete PCB-Substrat, hat einen ähnlichen in-plane CTE von 14-17 ppm/°C, aber sein durch-dicke CTE ist deutlich höher, oft 60-70 ppm/°C. Dieses Missverhältnis bedeutet, dass Kupfer und FR-4 bei steigender Temperatur mit unterschiedlichen Raten expandieren.
Verschweißt in einem Laminat kann keines der Materialien frei expandieren. Das Kupfer hält das FR-4 zurück, und das FR-4 hält das Kupfer zurück, wodurch innere Spannungen entstehen. Wenn die Platine gleichmäßig erhitzt wird und das Kupfer symmetrisch durch den Stackup verteilt ist, sind diese Spannungen handhabbar. Die Platine dehnt sich gleichmäßig aus, die Symmetrie des Stackups hält die neutrale Achse zentriert, und die ausbalancierten Kräfte auf oben und unten halten die Platine flach.
Gleichmäßige Erwärmung ist jedoch ein Luxus. Wenn ein Bereich einer Platine heißer wird als ein anderer, möchte dieser sich mehr ausdehnen. An den kühleren Bereich gekettet, kann er das nicht, und Spannungen bauen sich entlang der Grenze auf. Wenn der thermische Gradient stark ist und konstant in eine Richtung orientiert ist—ein Seite der Platine ist immer heißer als die andere—wird die Platine sich krümmen oder drehen, um die Spannung abzubauen, und eine neue Gleichgewichtform suchen, die die innere Spannungsenergie minimiert.
Der Zeitpunkt ist entscheidend. FR-4 wird deutlich nachgiebiger, wenn es sich seinem Glasübergangstemperatur (typischerweise 170-180°C) nähert oder darüber liegt. Während des Reflow-Peaks, bei oder über 240°C, ist das Substrat am wenigsten starr. Dies ist sein Moment der größten Verwundbarkeit. Ein thermisches Ungleichgewicht zu diesem Zeitpunkt wird die Platine verziehen. Wenn diese Verformung die Fließgrenze des erweichten Harzes überschreitet, erholt sich die Platine beim Abkühlen nicht vollständig in ihre Form.
Kupfer: Thermische Masse und Wärmeleitung
Während des Reflow-Prozesses spielt Kupfer zwei Rollen: Es wirkt als thermische Masse und als Hitze-Hochway. Beide sind Konsequenzen seiner physikalischen Eigenschaften – hoher spezifischer Wärmekapazität und außergewöhnlich hohe thermische Leitfähigkeit im Vergleich zu FR-4.
Als thermische Masse bestimmt Kupfer die Energie, die benötigt wird, um seine Temperatur anzuheben. Eine Platine mit schweren Kupferflächen benötigt mehr Energie und Zeit, um die Reflow-Temperatur zu erreichen, als eine mit spärlichen Spuren. Das bedeutet, dass Bereiche mit hoher Kupferdichte langsamer erwärmt werden als Bereiche mit niedriger Dichte. Hat eine Platine große, feste Kupferflächen auf der linken Hälfte und nur leichte Leitungen auf der rechten, verzögert sich die Temperatur der linken Hälfte während des Anstiegs. Zu jedem Zeitpunkt ist die rechte Hälfte heißer, was die thermische Asymmetrie erzeugt, die die Krümmung antreibt.
Als Hitze-Hochway ermöglicht die hohe thermische Leitfähigkeit von Kupfer (ungefähr 400 W/m·K im Vergleich zu 0,3 W/m·K bei FR-4), dass es die Hitze schnell umverteilt. Eine große Kupferfläche erwärmt sich nicht nur langsam aufgrund ihrer Masse; sie verteilt auch die Hitze von lokalen Hotspots aus, wodurch die Temperatur gleichmäßig verteilt wird. Während dies vorteilhaft sein kann, bedeutet es auch, dass die Anwesenheit oder Abwesenheit von Kupfer grundlegend unterschiedliche thermische Zonen schafft. Eine Region mit einer festen Fläche reagiert langsam und gleichmäßig auf Temperaturänderungen. Eine Region mit nur Spuren hat eine schnelle, lokale Reaktion.

Kupfer fügt nicht nur Masse hinzu; es verändert grundlegend die thermische Landschaft der Platine. Deshalb muss seine Verteilung als eine Frage des thermischen Designs betrachtet werden, nicht nur der Fertigungsuniformität.
Wie die Kupferverteilung die Heizsymmetrie steuert
Thermische Symmetrie bedeutet, dass alle Bereiche der Leiterplatte ungefähr zur gleichen Zeit die gleiche Temperatur erreichen. Während perfekte Symmetrie unmöglich ist, besteht das Ziel darin, thermische Gradienten zu minimieren, insbesondere während der Spitzenphase des Reflows, wenn die Leiterplatte am flexibelsten ist.
Die Kupferverteilung bestimmt diese Symmetrie, indem sie die thermische Masse und die Leitfähigkeitskarten der Platine definiert. Eine Platine mit gleichmäßiger Kupferdichte hat eine relativ einheitliche thermische Reaktion und absorbiert Wärme als Ganzes. Eine Platine mit stark ungleichmäßiger Kupferverteilung wird zu einem Patchwork aus Zonen mit unterschiedlichen thermischen Zeitkonstanten – dichte Bereiche sind im Rückstand, während spärliche Bereiche vorauslaufen.
Das Problem verschärft sich bei Mehrlagern. Betrachten Sie ein Sechslag-Design, bei dem die Stromschichten nur die Hälfte der Platinenfläche abdecken. Diese Hälfte hat eine deutlich höhere thermische Masse. Während des Reflow-Prozesses erwärmt sie sich langsamer, wodurch ein anhaltender Gradient von der spärlichen zur dichten Seite entsteht. Wenn dieser Gradient entlang der Länge der Platine verläuft, bowt sie. Bei rotationaler Asymmetrie dreht sie sich.
Das Reflow-Profil kann dies verschärfen. Die Soak-Zone eines Profils ist darauf ausgelegt, die Temperaturen vor dem endgültigen Anstieg zum Höhepunkt auszugleichen, aber sie ist nicht unendlich lang. Wenn eine Platine eine signifikante thermische Massenungleichheit hat, ist das Soaking möglicherweise nicht ausreichend. Wenn der Ofen auf 240-250°C ansteigt, überschießen die Regionen mit niedriger Masse zuerst, während die Hoch-Masse-Bereiche noch nachziehen. Dies ist das kritische Fenster, in dem die Krümmung beginnt.
Sobald sich unterschiedliche thermische Zonen bilden, interagieren sie. Eine große Kupferfläche in einem dichten Bereich zieht Wärme in sich auf, hält diesen Bereich länger kühler und verstärkt den Gradient zu den angrenzenden spärlichen Bereichen. Ohne den thermischen Puffer des Kupfers erwärmen sich diese spärlichen Bereiche schnell. Der Gradient bleibt während des Höhepunkts bestehen, und die Platine verbiegt sich.
Die Blanket Diebstahlfalle
Das Instinkt, Kupfer zu stehlen, basiert auf gültigen Fertigungsbedenken wie gleichmäßiger Ätzung und Beschichtung. Aber wenn es als allgemeine Füllung verwendet wird, um einen Zielprozentsatz zu erreichen, schafft das Stehlen oft die genau die thermische Asymmetrie, die es verhindern sollte.
Es wird zum Problem.
Wenn hinzugefügter Kupfer neue Ungleichgewichte schafft
Die Diebstahl erhöht die thermische Masse der Bereiche, in denen er hinzugefügt wird. Auf einer Leiterplatte mit funktionierendem Kupfer, das in einigen Bereichen konzentriert ist, und sparsamen Verbindungen in anderen, wird die Diebstahltechnik typischerweise nur in den spärlichen Regionen angewendet. Diese Bereiche, die zuvor eine niedrige thermische Masse hatten und schnell erhitzten, erwärmen sich jetzt langsamer.
Dies entfernt nicht das schwere funktionale Kupfer; es verschiebt nur das thermische Gleichgewicht. Wenn das Stehlen aggressiv genug ist, kann es das Gleichgewicht zu sehr verschieben. Das zuvor spärliche Gebiet könnte jetzt eine thermische Masse haben, die mit den funktionalen Bereichen vergleichbar ist, aber mit einer anderen Geometrie, was zu einem neuen und unvorhersehbaren Ungleichgewicht führt.
Das Problem liegt nicht nur im Dichtegrad, sondern auch in der Lage und Absicht. Wenn Stehlen in einem Gebiet platziert wird, das während des Reflow-Prozesses bereits kühler ist, macht das Hinzufügen von thermischer Masse dort es noch kühler, was den Gradient verschärft. Allgemeine Stehlstrategien unterscheiden nicht; sie wenden Füllung basierend auf einem Dichteziel an, nicht auf thermischer Analyse. Das Ergebnis ist oft mehr Kupfer, wo es nicht sein sollte.
Ein spezifischer Fehlerfall tritt auf, wenn Stehlen auf äußeren Schichten direkt über inneren Schichtflächen hinzugefügt wird. Diese Oberflächenmasse absorbiert Wärme aus dem Ofen und leitet sie nach innen. Wenn die inneren Schichten bereits eine hohe thermische Masse haben, erhöht das äußere Stehlen die Gesamtmasse dieses Stapels, ohne die Wärmeaufnahme zum Kern zu verbessern. Der Kern hinkt weiter hinterher, der Gradient von Oberfläche zu Kern erhöht sich, und im Querschnitt baut sich Spannung auf, die zu in-plane-Verformungen führt, da die Oberflächenschichten sich mehr ausdehnen als der Kern.
Stehlen bei Spitzen-Temperatur
Der Reflow-Peak ist der Moment höchster thermischer Belastung und geringster Substratsteifigkeit. Jede hier vorhandene thermische Ungleichheit wird die größte Auswirkung haben, weil die Fähigkeit des Boards, sich zu verformen, am niedrigsten ist. Thieving verankert eine thermische Struktur. Wenn diese Struktur ein Ungleichgewicht erzeugt, das sich bei Spitzen-Temperaturen manifestiert, wird dies jedes Mal geschehen, wenn das Board durch einen Ofen läuft.
Der Ofen kann ein Ungleichgewicht, das in der Konstruktion des Boards intrinsisch ist, nicht lösen. Wenn der Ofen die Hitze erhöht, um kühle, massereiche Regionen auf Temperatur zu bringen, werden thermisch reagierende Regionen zu hoch ausschlagen. Das Board erreicht seinen Höhepunkt mit unterschiedlichen Bereichen bei unterschiedlichen Temperaturen. Die heißeren Bereiche dehnen sich stärker aus, die kühleren Bereiche weniger. Das Board ist weich. Es dreht sich. Beim Abkühlen kann sich die Verformung dauerhaft ausprägen, was Komponenten aus der Position bringt und Lötstellen beeinträchtigt – ein Versagen, das bei normalen elektrischen Tests unsichtbar bleibt.
Stackup-Symmetrie: Die primäre Warpage-Kontrolle
Der effektivste Weg, Verformungen zu kontrollieren, ist die Gestaltung eines Board-Aufbaus, der thermisch und mechanisch symmetrisch um seine zentrale Ebene ist. Dadurch werden thermische Ausdehnungs-kräfte auf die obere Hälfte des Boards durch gleiche und entgegengesetzte Kräfte auf die untere Hälfte ausgeglichen. Ohne resultierenden Biegemoment bleibt das Board flach.
Ausgleichende Kupfer, Plane zu Plane
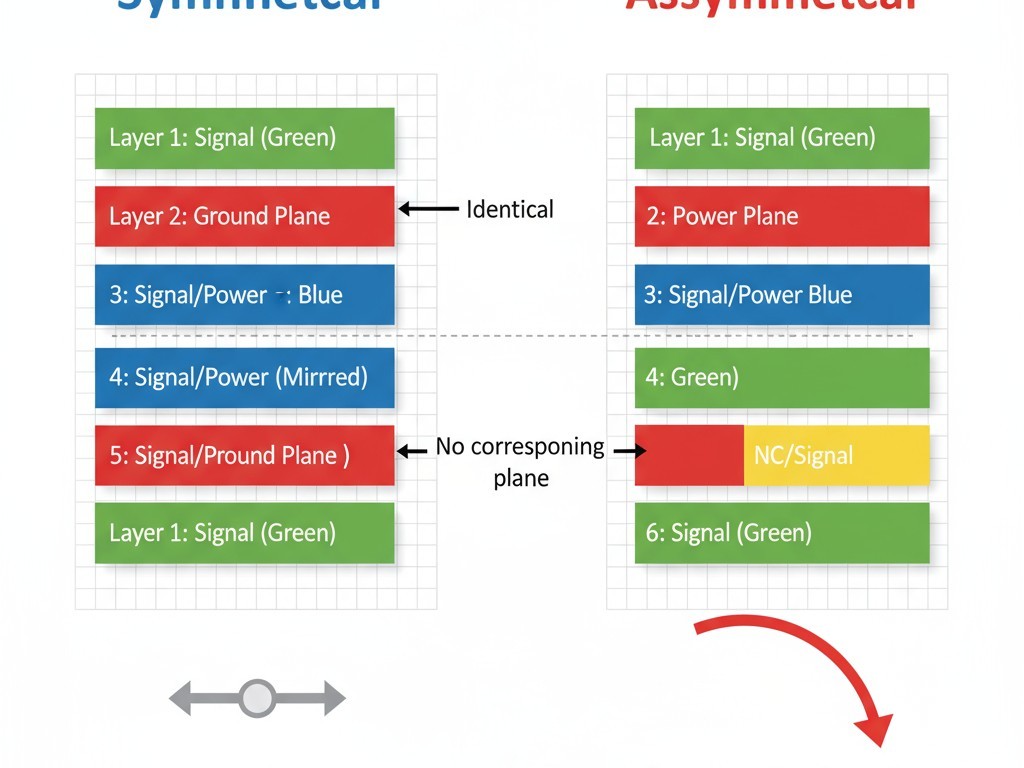
Das Verhältnis von Aufbau bedeutet, dass für jede Kupferform auf einer Schicht eine entsprechende Form auf einer der vom Zentrum des Boards gleich entfernten Schichten existiert. Bei einem Aufbau mit sechs Schichten sollte Schicht zwei die Spiegelung von Schicht fünf sein, und Schicht drei sollte die Spiegelung von Schicht vier sein. Wenn Schicht zwei eine durchgehende Massegrundlage ist, sollte Schicht fünf eine durchgehende Massegrundlage mit gleicher Fläche und Dicke sein. Dieses Spiegelbild balanciert die thermische Masse durch die Dicke des Boards und sorgt dafür, dass die obere und untere Hälfte bei gleicher Rate erwärmt werden. Die Spannung durch CTE-Unebenheit ist weiterhin vorhanden, aber sie ist symmetrisch, sodass sich das Board gleichmäßig ausdehnt, ohne sich zu biegen.
Die äußeren Schichten (eins und sechs) sollten ebenfalls ausgeglichen sein. Während identisches Kupfer oft unmöglich ist aufgrund der Bauteilplatzierung, besteht das Ziel darin, das gesamte Kupfergewicht und die Verteilung so nah wie möglich zusammenzuhalten. Auch die Materialauswahl ist entscheidend; Kern- und Prepreg-Dicken sollten spiegelbildlich um die Mitte herum sein, um die mechanischen und thermischen Neutralachsen auszurichten und die Verformungsresistenz des Boards zu maximieren.
Wenn die Stapelmodifikation eingeschränkt ist
Perfekte Symmetrie ist nicht immer möglich. Die Kosten können die Anzahl der Schichten festlegen oder das Design kann Plane erfordern, die nicht gespiegelt werden können. Ein Board mit einem großen Massegrundlagen auf Schicht zwei ohne entsprechende Plane auf Schicht fünf ist inhärent asymmetrisch.
In diesen Fällen ist eine Möglichkeit, eine nicht-funktionale, partielle Plane auf der spiegelbildlichen Schicht zu verwenden. Eine schraffierte oder maschenartige Kupferfläche, die die gleiche Fläche bedeckt, erhöht die thermische Masse und verbessert die Symmetrie, ohne eine durchgehende elektrische Plane zu schaffen. Dieser Kompromiss kann die Verformung oft auf akzeptable Werte reduzieren. Der Nachteil ist ein erhöhter Kupferverbrauch für eine nicht-funktionale Funktion, ein Kostenfaktor, der gegen den Ertragsverlust durch Verformung abgewogen werden muss.
Wenn die Symmetrie des Aufbaus beeinträchtigt ist, ist das Board anfälliger für Verformung, und die Toleranz ist eng. Das Hinzufügen von aggressivem Thieving zu einem schon asymmetrischen Aufbau ist besonders riskant, da es mit der vorhandenen Ungleichheit auf unvorhersehbare Weise interagieren kann.
Kontrollierte Kupferdichte ohne aggressive Füllung
Wenn die Symmetrie des Aufbaus die primäre Verteidigung ist, ist kontrollierte Kupferdichte das taktische Werkzeug, um lokale Ungleichheiten zu steuern. Das Ziel besteht darin, Kupfer nur dort hinzuzufügen, wo es gebraucht wird, in der erforderlichen Menge, ohne neue thermische Probleme zu erzeugen. Dies erfordert einen Übergang vom globalen zum lokalen Ausbalancieren, verbunden mit mechanischer Unterstützung beim Reflow.
Lokale Ausbalancierung statt globaler Füllung
Lokale Ausbalancierung bedeutet, die Kupferdichte in bestimmten Regionen gezielt anzugehen, anstatt überall ein einheitliches Füllmuster anzuwenden. Der Prozess beginnt mit der Identifizierung einiger und seltener Kupferbereiche, um dann anhand intuitiver thermischer Überlegungen zu entscheiden, wo hinzugefügtes Kupfer hilfreich ist und wo schädlich sein könnte.
Wenn ein Gebiet mit sehr niedriger Dichte von Regionen mit moderater Dichte umgeben ist, kann eine moderate Thieving-Strategie die thermische Diskontinuität abmildern. Das Ziel ist nicht, eine globale Dichte zu erreichen, sondern den Gradient zu verringern. Wenn die umliegenden Bereiche 30% Kupfer haben und der spärliche Bereich 5%, kann es genug sein, ihn auf 15% zu bringen. Mit aggressivem Thieving auf 30% könnte das Ziel überschritten werden.
Das bedeutet auch, Thieving zu vermeiden, wo es nicht benötigt wird. Kupfer in einem thermisch stabilen Bereich hinzuzufügen, nur um ein beliebiges globales Dichteziel zu erreichen, erhöht unnötig die thermische Masse und verschiebt das Gleichgewicht. Das ist die Falle starrer Designregeln, die Verteilung ignorieren. Auch die Geometrie der Füllung ist entscheidend. Schraffierte oder gepunktete Muster erzeugen eine geringere effektive thermische Masse als durchgehende Flächen und ermöglichen eine feinere Steuerung. Sie können die Fertigungsvorgaben erfüllen, ohne das thermische Verhalten eines Bereichs zu dominieren.
Der praktische Ansatz: Verwenden Sie grobe, niedrigdichte Füllungen nur dort, wo es erforderlich ist, um die Mindestanforderungen eines Herstellers zu erfüllen. Begründen Sie jede Kupferzugabe regionsweise, nicht als globale Operation.
Panel-Unterstützung und Werkzeugbau
Panel-Unterstützung ist eine mechanische Strategie, die das thermische Design ergänzt. Selbst eine Leiterplatte mit einigen thermischen Ungleichheiten kann flach gehalten werden, wenn sie im Reflow-Ofen ausreichend gestützt wird. Die Unterstützung begrenzt die Verformung der Leiterplatte, wenn sie ihren vulnerablem, hochtemperaturbereich durchläuft.
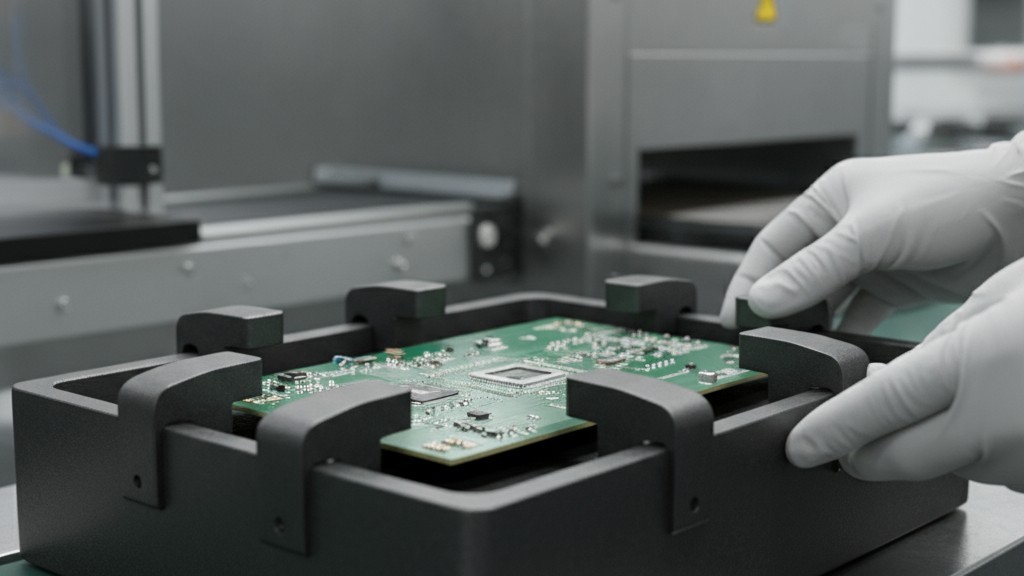
Eine Leiterplatte, die noch an ihre Panel befestigt ist, wird durch die Panel-Schienen eingeschränkt, die steifer sind und die gesamte Baugruppe flach halten. Aus diesem Grund werden viele Hochzuverlässigkeitsbaugruppen im Panel-Reflow-Verfahren gefertigt. Für einzelne Leiterplatten bietet eine Reflow-Träger- oder Vorrichtung die gleiche Funktion. Diese starren Rahmen, oft aus Materialien mit niedrigem CTE wie Graphitverbundwerkstoff, halten die Leiterplatte durch mechanische Kraft flach. Der Kompromiss ist das thermische Eigengewicht des Trägers, das das Reflow-Profil beeinflussen kann.
Unterstützung eliminiert das thermische Ungleichgewicht nicht; sie unterdrückt die daraus resultierende Verformung. Die Leiterplatte steht weiterhin unter innerem Stress, was die Lötstellen beeinflussen kann. Unterstützung ist daher eine Gegenmaßnahme, kein Allheilmittel. Die besten Ergebnisse erzielen Sie, indem Sie thermische Ungleichheiten durch Design minimieren und mechanische Unterstützung einsetzen, um das Rest-Risiko zu steuern.
Entscheidung, wann Diebstahl gerechtfertigt ist
Kupferdiebstahl ist grundsätzlich nicht schlecht. Es wird problematisch, wenn es blind angewendet wird, als Ersatz für eine ordnungsgemäße Stapelungsplanung und Dichtheitskontrolle. Die Entscheidung, es zu verwenden, sollte wohlüberlegt sein.
Wann ist es gerechtfertigt?
- Um die Minimumanforderungen bei der Fertigung zu erfüllen. Viele Hersteller verlangen eine Mindestkupferdichte (z.B. 20-30-%) für eine gleichmäßige Plattierung. Falls ein Design darunter liegt, ist eine Füllung obligatorisch. In diesem Fall fügen Sie nur so viel Kupfer hinzu, wie das Minimum erfordert, unter Verwendung von niedrigdichten Mustern. Dies ist eine Fertigungsbeschränkung, keine thermische Optimierung.
- Wenn die thermische Simulation einen deutlichen Nutzen zeigt. In einigen Fällen kann die Modellierung zeigen, dass das Hinzufügen von Kupfer zu einem bestimmten Hot Spot dessen thermische Masse so erhöht, dass er mit den angrenzenden Bereichen in Balance kommt. Dies ist der richtige, chirurgische Einsatz von Diebstahl als thermisches Werkzeug, das Gegenteil eines blanket fill.
- Wenn die Leiterplatte von Natur aus starr ist. Dicke, kleine oder hoch-symmetrische Leiterplatten können aggressiven Diebstahl ohne Probleme tolerieren. Die Entscheidung basiert auf Risikoabwägung. Wenn eine Leiterplatte grenzwertig ist — dünn, groß oder asymmetrisch — muss der Diebstahl streng kontrolliert werden.
Das Leitprinzip ist Sparsamkeit. Fügen Sie Kupfer nur bei Bedarf hinzu, wenn klar ist, dass es kein schlimmeres Problem verursachen wird. Bevorzugen Sie minimalen, lokalisierte Diebstahl. Verlassen Sie sich zunächst auf die Stapelungssymmetrie für den thermischen Ausgleich und verwenden Sie Panel-Unterstützung zur Risikosteuerung. Betrachten Sie Dasitmühl als gezielte Korrektur, nicht als eine Standard-Endbearbeitung. Ihre Leiterplatten werden beim Reflow flach sein, und Ihre Fertigungsquote wird diese Disziplin widerspiegeln.
